赛灵思专家:薄化制程良率升级,2.5D硅中介层晶圆成本下降
是存储器、逻辑或电源元件应用专用的。然而,晶圆厂和委外的封装测试服务商,也必须拥有对这些不同应用需求的支援能力,亦即他们可以同时采用不同的黏着剂。EV Group最近推出的ZoneBOND技术--一种室温下机械式剥离方法,为供应商朝向开放、多元的发展带来突破。藉由这项技术,载具可具备剥离的功能。
图1所示即为ZoneBOND载具晶圆,其中心是黏着力较弱的部分,而边缘部位则有最强的黏着力。图2所示的是剥离制程。首先,边缘部位的黏着剂在 Edge Zone Release(EZR)制程的单晶圆模式下溶解,然后元件晶圆会在Edge Zone Debond (EZD)制程中从载具晶圆上分离出来。薄化晶圆贴膜,以进行之后的晶圆切割和封装制程。实际的剥离过程会在载具晶圆和黏着剂薄膜之间进行。在此剥离制程中,凸块可安全地嵌入黏贴薄膜中,且在剥离过程中凸块不会承受任何外力。目前提供ZoneBOND材料的不同黏着剂供应商已有一个开放的共同平台,形成一个多样化的供应链。

图1 ZoneBOND载具架构放大简图
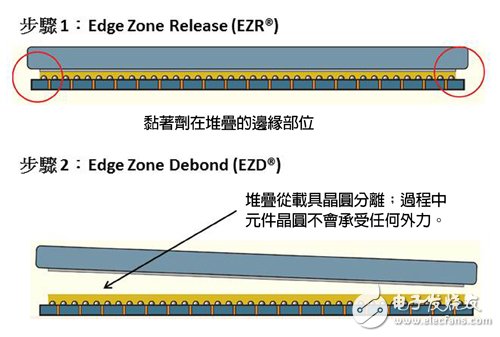
图2 ZoneBOND剥离制程是两步骤的製程:在分离的步骤时黏着剂的边缘部分就会溶解;薄化晶圆会在剥离的步骤中与载具分离。
标准化制程与设备襄助 2.5D IC薄化晶圆成本下降
换言之,ZoneBOND技术可让制程标准化并让黏着剂独立于制程设备。透过此技术,暂时接合和剥离工具可以采用任何一种黏着剂,如旋转涂胶机(Spin Coater)一样,临时键合和键合分离设备可以在涂胶过程中采用任何一种光阻剂 (Photoresist)。因此,在制程中可使用来自众多厂商的各种不同的黏着剂。制程和设备的标准化是让产业体系更有竞争力的关键,这不仅有助于为 2.5D IC应用降低薄化晶圆制程的成本,同时也为3D IC应用带来相同的效益。
3DIC xilinx soc mems LED 相关文章:
- 封测领域风云再起 巨头布建3D IC封测产能(06-30)
- 通过应用案例告诉你:赛灵思如何做到领先一代(02-12)
- 后摩尔定律时代:终于跨越鸿沟?(06-27)
- UltraScale可编程架构如何解决互连问题?(06-09)
- 如何打破3DIC设计与电源完整性之间的僵局(08-22)
- 赛灵思ASIC级UltraScale架构要素及相关说明(06-09)
