晶圆级封装: 热机械失效模式和挑战及整改建议

图10:[A] 直接配置和锥体配置的BEoL层和聚合物层应力分布图[B] BEoL栈周围应力变化(见应力提取通道图[A]上的灰箭头) (独立封装配置)
在决定了边缘设计方法后,我们需要确定在BEoL栈上发生较低应力的准确位置。为此,我们测试了各种位置:平坦区(图11 #1, #4)、密封环(图11 #6)上方、钝化拓扑底部不同位置(图11 #2 #3 #5)。
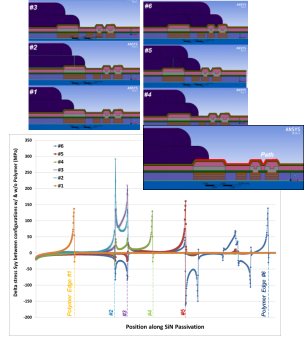
图11:有聚合物的配置与无聚合物的配置之间的应力变化。在SiN钝化层内提取拉伸应力Sy。不同配置间的应力差异主要出现在聚合物边缘。
鉴于聚合物末端在BEoL栈上产生拉伸性负载,确定选项#6为首选。因此,密封环的‘锚定’特性可限制其潜在的不利影响。为辨别结构差异,关注点放在钝化层应力上。
不出所料,发现两个大类:第一类(#2, #3 & #5)是聚合物层末端靠近一个几何奇点,引发最大应力;第二类(#1, #4 & #6)是聚合物层末端在一个平坦面上,这里观察到最小应力。提案#6(即密封圈上方)的改进作用并不明显,需要说明地是,这可能是所用分析标准造成的,本文只分析了SiN层的完整性,BEoL中间层的离层风险并未视为一种失效模式。基于这些结果和过程可变因素,将边缘置于较大的平坦区域是比较安全的,这对应配置#4。
钝化性质
聚合物层边缘、暴露于空气中的结构和焊盘的存在,让WLCSP封装的钝化层成为一个重要区域。开发人员可以从厚度和残余应力角度探讨最佳设计。因为我们跟踪的失效类型是机械失效,所以讨论重点放在氮化物层的特性方面。为此,我们测试了不同厚度与残余应力的相对变化,见表1.


表1.探讨过的参数表
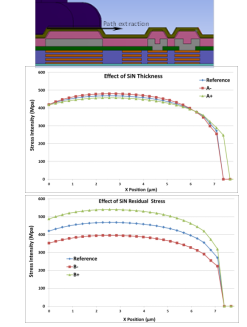
图12:[A]SiN厚度的影响[B]SiN残余应力的影响
应力是从聚合物层下面的SiN层提取的(图12)。测试结果显示,SiN越厚,应力越小。还应记住,如果厚度较大,真层拓扑可能会更平滑,奇点更少,因此,可降低失效风险。关于残余应力影响,根据最初假定值,最终应力被迁移。因此,通过降低残余应力,降低了最终应力状态的数学值。不过,增加厚度方法不能随意修改,还要记住对其它特性(例如,电气、可靠性和热变形)的影响。因此,必须找到一个折衷的办法,考虑到所有的副作用。
4. 结论
本文概述了WLCSP晶圆级封装的特异性,先简要介绍了扇入和扇出型封装特异性以及封装流程;然后,描述了在制程工序和/或可靠性测试期间发生的不同的热机械失效。裸片边缘带和焊球四周是高度敏感区域,发生过很多失效问题。为更深入地了解所涉及的结构,本文采用有限元法分析了WLCSP封装失效问题。首先,建立一个3D封装模型,初步了解扇入型封装的热机械特性。研究发现,焊球和聚合物边缘是影响可靠性的重要位置。然后,用一个2D模型深入分析聚合物边缘的影响,优化BEoL层。实验发现,终止在平坦区域的锥体沉积法可降低在BEoL钝化层发生的应力。最后,我们研究了SiN厚度及残余应力的影响,并建议提高SiN层厚度,以降低残余应力。
本文能够让读者朋友更好地了解WLCSP封装在机械性能方面的特异性。通过介绍一组与有限元法结果相关的典型失效,我们概括了主要有效参数和可靠性改进建议。
- 研调:IDM委外扩大 晶圆代工Q1产值将持平(02-18)
- 台积电14厂4期装机中(02-21)
- 大陆硅晶圆缺货严重 暂不敢接单(02-23)
- 英特尔总裁唱衰晶圆代工业(02-23)
- 调查显示:Fabless IC业者最大IP来源是晶圆代工厂(02-24)
- 18寸晶圆量产时间再后延(02-28)
