后摩尔定律时代的PCB发展趋势分析
1. 前言
摩尔定律作为电子制造产业链的金科玉律,一直屹立于科技发展的前沿,给整个电子制造产业链指明了非常明晰的发展方向,可谓厚泽万物。但近些年,由于IC制造过程中使用的光刻技术(Photolithography)相对于摩尔定律显得相对滞后,IC业界给予厚望的EUV(Extreme UltraViolet)光刻设备也在紧锣密鼓的研发中,技术成熟度尚达不到量产的水平,使得IC制造成本在晶圆节点(Wafer Node)不断缩小的情况下,成本呈现指数增长;另一方面,2017年,苹果A11/A10X、高通骁龙835、三星Exynos 8895、华为Kirin970和联发科Helio X30蓄势待发,晶圆节点已经发展到10nm量产的阶段,已经非常接近FinFET制程的物理极限5nm,也即即便EUV光刻设备可以量产使用,也无法改变摩尔定律即将死亡的趋势。那接下来电子制造行业该何去何从?业界和学界也给出了比摩尔定律更为多元化的答案:more moore(深度摩尔,IC制造角度的摩尔定律)和more than moore(超越摩尔,IC封装角度的摩尔定律),见图1:

图 1 后摩尔定律时代Roadmap
何谓深度摩尔(more moore,IC制造角度的摩尔定律),是延续CMOS(FinFET)的整体思路,在器件结构、沟道材料、连接导线、高介质金属栅、架构系统、制造工艺等等方面进行创新研发,沿着摩尔定律一路scaling(每两到三年左右,晶体管的数目翻倍),见图2 Logic IC的roadmap: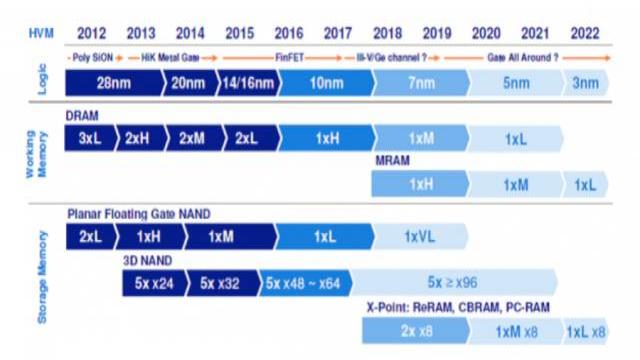
图 2 Wafer Node Roadmap
目前深度摩尔一般适用于数字电路,如智能手机中的处理器(AP)和基带芯片(Base Band),均属于SoC的范畴。前面我们也提到,由于FinFET的物理极限是5nm,那么发展到5nm后如何继续呢?那就必须打破FinFET的结构和材料限制,开发和研究新的Transistor(switch)形式,如Tunneling FET(TFET)、Quantum Cellular Automata (QCA) 、SpinFET等,也即图1中所谓的Beyond CMOS。
何谓超越摩尔(more than moore,IC封装角度的摩尔定律),主要侧重于功能的多样化,是由应用需求驱动的。之前集成电路产业一直延续摩尔定律而飞速发展,满足了同时期人们对计算、存储的渴望与需求。但芯片系统性能的提升不再靠单纯的暴力晶体管scaling,而是更多地依靠电路设计以及系统算法优化,同时集成度的提高不一定要靠暴力地把更多模块放到同一块芯片上,而是可以靠封装技术来实现集成。模拟/射频/混合信号模块等不需要最先进工艺的模块可以用较成熟且廉价的工艺实现(比如为模拟射频工程师所喜闻乐见的65nm),而数字模块则可以由先进工艺实现,不同模块可以用封装技术集成在同一封装中,而模块间的通讯则使用高速接口。这种集成方式即异质集成(heterogeneous integration),是目前在工业界和学界都非常火的SiP,不但可以减低成本,而且可以更加集成化,见图3(b)。智能手机中的射频前端模块、WiFi模块、蓝牙模块和NFC模块等模拟电路均适用于超越摩尔的情景。
回头再看摩尔定律的两个方向,无非就是SoC和SiP的差异,一个是IC设计角度,一个是IC封装角度,见图3,也可是数字电路与模拟电路的差异。这样,再去理解SoC和SiP何其简单。
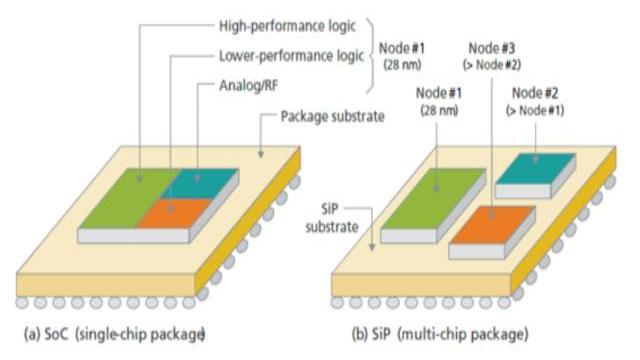
图 3 SoC与SiP
那我们再把视线从理论预测转向实际应用,作为消费电子时代的弄潮儿苹果公司自然是大家讨论技术走向的焦点。随着苹果公司发布iPhone 10周年的临近,纪念版iPhone的消息更是纷至沓来,让人目不暇接,其最新技术走向更是值得大家分析揣测。
首先就是2016年9月iPhone 7的A10 Fusion首次采用TSMC 16nm 的InFoWLP封装技术,完全取代了以往的FCCSP的封装技术,而今年9月即将发布的纪念版iPhone A11将采用TSMC 10nm的InFoWLP封装技术,而与之对应的主板则会革命性地将载板的精细线路制造技术MSAP导入PCB行业,重新定义了电子制造产业链,由于原来的IC制造(TSMC)?IC封装(ASE)+IC载板?SMT(Foxconn)+PCB的制造流程改为IC制造(TSMC)? SMT(Foxconn)+PCB,也即把IC封装融入IC制造,PCB直接代替IC载板。那我们不难发现,这种是基于深度摩尔由于AP 升级(16nm至10nm)而带来的革命性改变。
其次是苹果Apple Watch的发布,其最具特色的就是S1芯片(见图4)的封装技术,即SiP封装技术(System in Package),不但把AP应用处理器(已经集成了SRAM内存)、NAND闪存、各种传感器、特殊用途芯片、IO及功耗管理IC封装到了一起,而且还把其他被动原件均集成在一块载板上,在这里其主板客串了两个角色:IC载板和PCB主板,其整个电子制造产业链
- 后摩尔定律时代,半导体厂商应该怎么做?(02-04)
