后摩尔定律时代的PCB发展趋势分析
加严格, 目前Ball Pitch已经发展至0.35mm,如果持续降低,将会造成下游PCB制造成本大大增加,于是Fan-Out WLP应运而生,见图9:所谓Fan-Out,即I/O bump可以通过RDL层扩展至IC芯片周边,在满足I/O数增大的前提下又不至于使Ball Pitch过于缩小从而影响PCB加工,见图10。
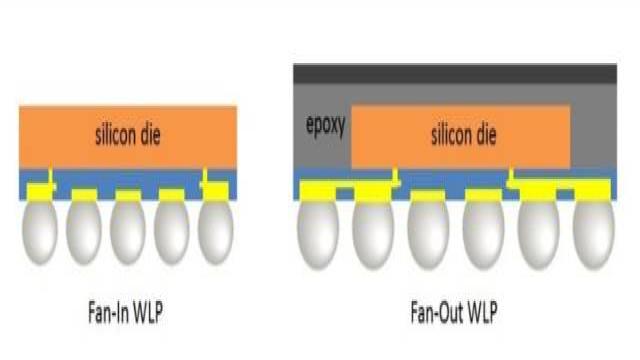
图 9 Fan-In and Fan-Out
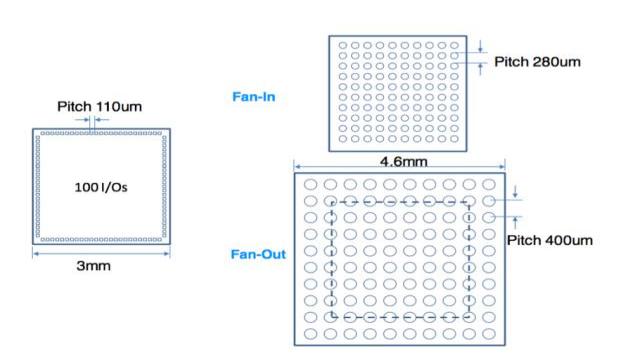
图 10 Fan-Out WLP
当然,Fan-Out WLP除了满足不断增加的I/O数的需求外,最大的特点就是其采用RDL层布线代替了传统IC封装所需的IC载板,从而大大降低了整体封装厚度,这一点极大地适应了消费类电子尤其是智能手机对厚度的极端苛求。基于此点,传统的FC-CSP和FC-BGA封装也逐渐向Fan-Out WLP过渡,当然也可理解为Fan-Out WLP是Fan-In WLP和FC载板封装的技术融合,见图11。可见Fan-Out WLP发展前景非同一般。
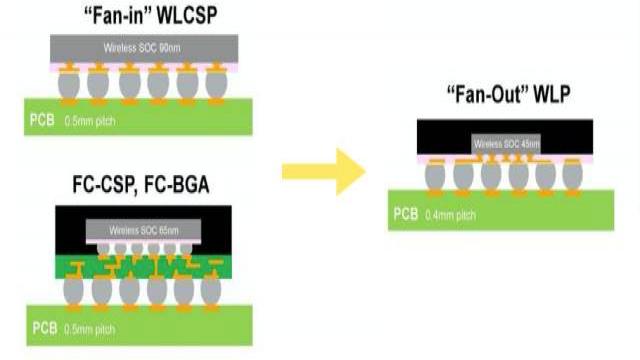
图 11 Fan-Out WLP发展趋势
伴随Fan-Out WLP技术兴起,相配套的PCB由于使用了IC载板的精细线路加工技术MSAP,其加工难度却又远高于常规HDI。另外,由于IC芯片采用Fan-Out WLP后,已经不再是裸芯片(IC载板是裸芯片封装,这也是IC载板区别于PCB的第三大特点),所以与之配套的PCB并不能称为载板,根据目前苹果电子产业链的业内人士所述,把采用Fan-Out WLP封装和采用MSAP工艺加工的PCB称为类载板PCB(SLP,Substrate-like PCB)。Apple 2016年发布的iPhone7的A10 Fusion已经采用TSMC InFoWLP工艺,但PCB仍然采用酸蚀流程,据了解,2017的A11芯片也将延续TSMC InFoWLP工艺,并且已经确定PCB采用MSAP流程,所以,类载板PCB的定义和技术指标也变得更加具体,见表格2:
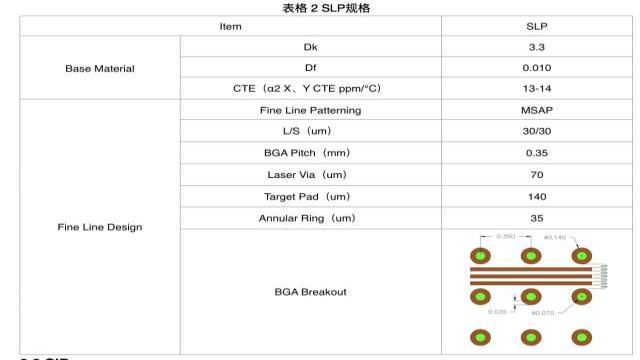
2.3 SiP
根据国际半导体路线组织(ITRS)的定义,SiP是从封装的角度出发,对不同芯片进行并排或叠加的封装方式,将多个具有不同功能的有源电子元件与可选无源器件,以及诸如MEMS或者光学器件等其他器件优先组装到一起,实现一定功能的单个标准封装件,形成一个系统或者子系统。
SiP可相当于一系统载板的相关功能芯片、电路的总和,而依据不同的功能芯片进行系统封装,可以采简单的Side by Side的MCM(Multi-chip Module)技术(2D Package),也可利用相对更复杂的多芯片封装MCP(Multi-chip Package)技术、芯片堆叠(Stack Die)等不同难度与制作方式进行系统组构(2.5D和3D Package)。也就是说,在单一个封装体内不只可运用多个芯片进行系统功能建构,甚至还可将包含前述不同类型器件、被动元件、电路芯片、功能模组封装进行堆叠,透过内部连线或是更复杂的3D IC技术整合, 构建成更为复杂的、完整的SiP系统功能。常见的SiP封装样式见表格3:
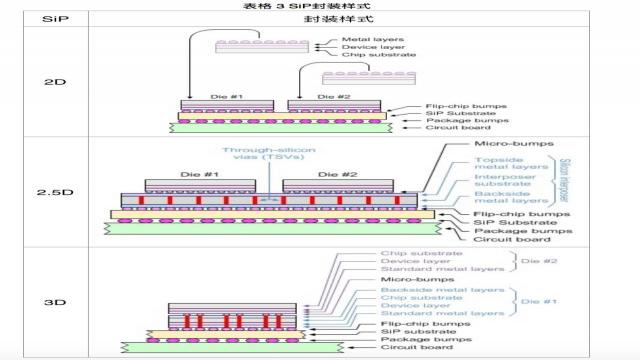
从上表可以看出,SiP 载板其实就是IC载板的一种,其技术和规格和传统BGA/CSP封装相同。前面我们提到的Apple Watch S1芯片采用SiP封装,其实是一种比较特殊的IC载板,既可称作IC载板也可称作PCB主板。
3. 未来电子制造技术的发展趋势及电子制造产业链整合
在后摩尔定律时代,正如前言所述,整个电子产业链正沿着深度摩尔和超越摩尔两条道路前行,也潜移默化的整合着整个电子制造产业链的布局。
3.1从深度摩尔角度看,Fan-Out WLP将延续封测领域的"先进制程",晶圆厂抢食封装厂订单
随着晶圆厂在先进制程上的进展,不断满足摩尔定律的要求,每一颗晶圆的尺寸在不断缩小。然而,同制造技术不同,后道封测并不完全遵从摩尔定律的发展,换言之,直接在晶圆上的植球尺寸,不会满足同比例缩小的技术演进。对于封测厂商来说,随着I/O口的增多和晶圆尺寸的缩小,如何再满足封装管脚的引出是一大挑战。而对于晶圆厂来说这确是一个机遇。今年9月即将发布的纪念版iPhone A11将采用TSMC 10nm的InFoWLP封装技术,而与之对应的主板则会革命性地将载板的精细线路制造技术MSAP导入PCB行业,重新定义了电子制造产业链,由于原来的IC制造(TSMC)?IC封装(ASE)+IC载板?SMT(Foxconn)+PCB的制造流程改为IC制造(TSMC)? SMT(Foxconn)+PCB,也即把IC封装融入IC制造,PCB直接代替IC载板。见图12:
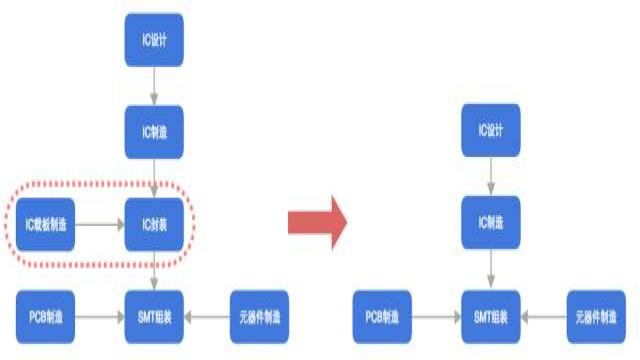
图 12 电子制造产业链整合趋势1
如此,曾经一度由封装厂主导和掌控的IC封装市场逐渐被IC制造企业晶圆厂吞食。各大晶圆厂如三星和Intel也在积极布局类似于InFoWLP的高端封装技术,逐渐抢夺原有IC封装厂的市场订单。
3.2从超越摩
- 后摩尔定律时代,半导体厂商应该怎么做?(02-04)
