PBGA向FBGA转变过程中的挑战
时间:10-12
来源:互联网
点击:
1 引言
从20世纪80年代中后期开始,电子产品正朝着便携式、小型化、网络化和多媒体化方向发展,这种市场需求对电路封装技术提出了相应的要求,单位体积信息的提高和单位时间处理速度的提高成为促进微电子封装技术发展的重要因素。
2 芯片封装技术的发展
数十年来,芯片封装技术一直追随着IC的发展而发展,一代IC就有相应一代的封装技术相配合,而SMT的发展,更加促进芯片封装技术不断达到新的水平。
60、70年代的中、小规模IC,曾大量使用TO型封装,后来又开发出DIP、PDIP,并成为这个时期的主导产品形式。80年代出现了SMT,相应的 IC封装形式开发出适于表面贴装短引线或无引线的LCCC、PLCC、SOP等结构。在此基础上,经十多年研制开发的QFP不但解决了LSI的封装问题,而且适于使用SMT在PCB或其他基板上表面贴装,使QFP终于成为SMT主导电子产品并延续至今。为了适应电路组装密度的进一步提高,QFP的引脚间距目前已从1.27mm发展到了 0.3mm。由于引脚间距不断缩小,I/O数不断增加,封装体积也不断加大,给电路组装生产带来了许多困难,导致成品率下降和组装成本的提高。另一方面由于受器件引脚框架加工精度等制造技术的限制,0.3mm已是QFP引脚间距的极限,这都限制了组装密度的提高。于是一种先进的芯片封装BGA(Ball Grid Array,焊球阵列)应运而生,一般使用层压基板取代传统封装用的金属框架。它的I/O端子以圆形的合金锡球或铅锡球按阵列形式分布在封装下面,引线间距大,引线长度短。BGA技术的优点是可增加I/O数和间距,消除QFP技术的高I/O数带来的生产成本和可靠性问题。
BGA的兴起和发展尽管解决了QFP面临的困难,但它仍然不能满足电子产品向更加小型、更多功能、更高可靠性对电路组件的要求,也不能满足硅集成技术发展对进一步提高封装效率和进一步接近芯片本征传输速率的要求,所以更新的封装FBGA(Fine Pitch BGA、CSP、Chip Size Package)又出现了,它的英文含义是封装尺寸与裸芯片相同或封装尺寸比裸芯片稍大。FBGA(CSP)与BGA结构基本一样,只是锡球直径和球中心距缩小了、更薄了,这样在相同封装尺寸时可有更多的I/O数,使组装密度进一步提高,可以说FBGA(CSP)是缩小了的BGA。
正是由于这些无法比拟的优点,才使FBGA(CSP)得以迅速发展并进入实用化阶段。从FBGA(CSP)近几年的发展趋势来看,FBGA(CSP)将取代QFP和部分BGA成为高I/O端子IC封装的主流,而且正越来越多地应用于移动电话、数码录像机、笔记本电脑等产品上。
3 PBGA与FBGA封装形式简介
STATS ChipPAC的PBGA封装(见图1)利用层压树脂线路板作为基板,并且可提供符合JEDEC标准的各种尺寸和球数,以满足客户要求。这种封装形式提供给了客户一个非常有成本效益的先进封装解决方案,与传统的框架封装形式相比,提供了更高的封装密度。
STATS ChipPAC的先进的设计和方针能力使得封装优化成为可能,以满足客户对电性能和热性能的最大需求。STATS ChipPAC通过结合成熟的工艺和设备、材料清单,取得了有竞争力的合格率、产品可靠性和性能。PBGA封装类型已有成熟的绿色和无铅的材料清单可供选择。
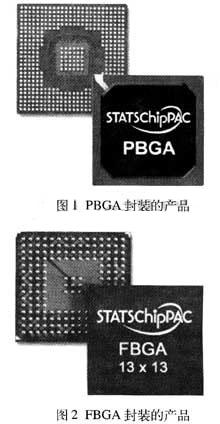
STATS ChipPAC的FBGA(见图2)是一种以层压树脂线路板为基板的芯片及封装形式。它采用的是全塑封并以低间距的锡球作为I/O口的连接。FBGA封装减小了产品的外形尺寸和产品厚度,但是有更高的密度,这一特点使之成为高性能、便携式应用产品的的理想的先进技术封装解决方案。配之最新的材料和先进的工艺,可生产出可靠的和有显著成本效益的产品。现有无铅和无卤素的材料清单可供选择。STATS ChipPAc可提供宽范围的、符合JEDEC标准的产品尺寸和厚度。例如:LFBGA(<1.70mm[典型的<1.40mm])、 TFBGA(<1.20mm)、VFBGA(<1.00mm)、WFBGA(<0.80mm)和UFBGA(<0.55mm) 等。
表1和表2分别列出了PBGA和FBGA之间的特性和应用比较。


4 PBGA向FBGA封装转变中的挑战
毫无疑问,同样的产品,若由FBGA替代PBGA封装,最大的挑战无疑是信号线之间的短路,尤其是对于高密度的产品,更是如此。从经验工艺水平来看,短路可能来源于三个方面。
4.1 焊线之间的短路
焊线之间的短路是整个项目的最大风险所在。由于FBGA采用的是矩阵式设计,一条层压基板设计成了多排多列的矩阵。在层压基板电镀工艺时,要求每个产品之间互联,虽然在做层压基板的断路/短路测试时,有些电镀线会被蚀刻断。但在焊线之后的断路/短路检测,仍然是一个很大的难题。所以我们从成本角度考虑,在封装工艺中取消断路/短路测试功能,而从封装工艺控制的角度和材料选择方面作了改进。
(1)减小焊线线径,选择较硬材质的金线。但是这两点特性与其他工艺品质互相矛盾。减小焊线直径,可以提高线间距,但是塑封时,更容易产生金线摇摆 (Wire Sweep)而导致线与线之间的短路,并且焊线的线弧控制也会变得不稳定。较硬材质的金线有助于抗金线摇摆,但是焊线时,需要更大的焊接功率和焊接力。对产品的质量和可靠性都是不小的威胁;
(2)选择较健壮的机器线弧参数,使用优化参数控制线弧角度和高度;
(3)选择精细填充剂的塑封树脂,并使用优化的塑封参数,有助于减小金线摇摆;
(4)焊线时,相邻的金线采用高低线弧,以增加线间距;进而,减小线与线之间短路风险。
从20世纪80年代中后期开始,电子产品正朝着便携式、小型化、网络化和多媒体化方向发展,这种市场需求对电路封装技术提出了相应的要求,单位体积信息的提高和单位时间处理速度的提高成为促进微电子封装技术发展的重要因素。
2 芯片封装技术的发展
数十年来,芯片封装技术一直追随着IC的发展而发展,一代IC就有相应一代的封装技术相配合,而SMT的发展,更加促进芯片封装技术不断达到新的水平。
60、70年代的中、小规模IC,曾大量使用TO型封装,后来又开发出DIP、PDIP,并成为这个时期的主导产品形式。80年代出现了SMT,相应的 IC封装形式开发出适于表面贴装短引线或无引线的LCCC、PLCC、SOP等结构。在此基础上,经十多年研制开发的QFP不但解决了LSI的封装问题,而且适于使用SMT在PCB或其他基板上表面贴装,使QFP终于成为SMT主导电子产品并延续至今。为了适应电路组装密度的进一步提高,QFP的引脚间距目前已从1.27mm发展到了 0.3mm。由于引脚间距不断缩小,I/O数不断增加,封装体积也不断加大,给电路组装生产带来了许多困难,导致成品率下降和组装成本的提高。另一方面由于受器件引脚框架加工精度等制造技术的限制,0.3mm已是QFP引脚间距的极限,这都限制了组装密度的提高。于是一种先进的芯片封装BGA(Ball Grid Array,焊球阵列)应运而生,一般使用层压基板取代传统封装用的金属框架。它的I/O端子以圆形的合金锡球或铅锡球按阵列形式分布在封装下面,引线间距大,引线长度短。BGA技术的优点是可增加I/O数和间距,消除QFP技术的高I/O数带来的生产成本和可靠性问题。
BGA的兴起和发展尽管解决了QFP面临的困难,但它仍然不能满足电子产品向更加小型、更多功能、更高可靠性对电路组件的要求,也不能满足硅集成技术发展对进一步提高封装效率和进一步接近芯片本征传输速率的要求,所以更新的封装FBGA(Fine Pitch BGA、CSP、Chip Size Package)又出现了,它的英文含义是封装尺寸与裸芯片相同或封装尺寸比裸芯片稍大。FBGA(CSP)与BGA结构基本一样,只是锡球直径和球中心距缩小了、更薄了,这样在相同封装尺寸时可有更多的I/O数,使组装密度进一步提高,可以说FBGA(CSP)是缩小了的BGA。
正是由于这些无法比拟的优点,才使FBGA(CSP)得以迅速发展并进入实用化阶段。从FBGA(CSP)近几年的发展趋势来看,FBGA(CSP)将取代QFP和部分BGA成为高I/O端子IC封装的主流,而且正越来越多地应用于移动电话、数码录像机、笔记本电脑等产品上。
3 PBGA与FBGA封装形式简介
STATS ChipPAC的PBGA封装(见图1)利用层压树脂线路板作为基板,并且可提供符合JEDEC标准的各种尺寸和球数,以满足客户要求。这种封装形式提供给了客户一个非常有成本效益的先进封装解决方案,与传统的框架封装形式相比,提供了更高的封装密度。
STATS ChipPAC的先进的设计和方针能力使得封装优化成为可能,以满足客户对电性能和热性能的最大需求。STATS ChipPAC通过结合成熟的工艺和设备、材料清单,取得了有竞争力的合格率、产品可靠性和性能。PBGA封装类型已有成熟的绿色和无铅的材料清单可供选择。
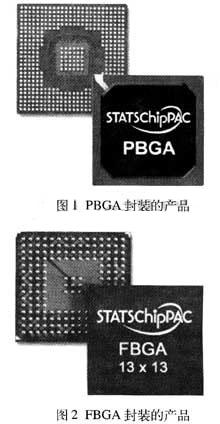
STATS ChipPAC的FBGA(见图2)是一种以层压树脂线路板为基板的芯片及封装形式。它采用的是全塑封并以低间距的锡球作为I/O口的连接。FBGA封装减小了产品的外形尺寸和产品厚度,但是有更高的密度,这一特点使之成为高性能、便携式应用产品的的理想的先进技术封装解决方案。配之最新的材料和先进的工艺,可生产出可靠的和有显著成本效益的产品。现有无铅和无卤素的材料清单可供选择。STATS ChipPAc可提供宽范围的、符合JEDEC标准的产品尺寸和厚度。例如:LFBGA(<1.70mm[典型的<1.40mm])、 TFBGA(<1.20mm)、VFBGA(<1.00mm)、WFBGA(<0.80mm)和UFBGA(<0.55mm) 等。
表1和表2分别列出了PBGA和FBGA之间的特性和应用比较。


4 PBGA向FBGA封装转变中的挑战
毫无疑问,同样的产品,若由FBGA替代PBGA封装,最大的挑战无疑是信号线之间的短路,尤其是对于高密度的产品,更是如此。从经验工艺水平来看,短路可能来源于三个方面。
4.1 焊线之间的短路
焊线之间的短路是整个项目的最大风险所在。由于FBGA采用的是矩阵式设计,一条层压基板设计成了多排多列的矩阵。在层压基板电镀工艺时,要求每个产品之间互联,虽然在做层压基板的断路/短路测试时,有些电镀线会被蚀刻断。但在焊线之后的断路/短路检测,仍然是一个很大的难题。所以我们从成本角度考虑,在封装工艺中取消断路/短路测试功能,而从封装工艺控制的角度和材料选择方面作了改进。
(1)减小焊线线径,选择较硬材质的金线。但是这两点特性与其他工艺品质互相矛盾。减小焊线直径,可以提高线间距,但是塑封时,更容易产生金线摇摆 (Wire Sweep)而导致线与线之间的短路,并且焊线的线弧控制也会变得不稳定。较硬材质的金线有助于抗金线摇摆,但是焊线时,需要更大的焊接功率和焊接力。对产品的质量和可靠性都是不小的威胁;
(2)选择较健壮的机器线弧参数,使用优化参数控制线弧角度和高度;
(3)选择精细填充剂的塑封树脂,并使用优化的塑封参数,有助于减小金线摇摆;
(4)焊线时,相邻的金线采用高低线弧,以增加线间距;进而,减小线与线之间短路风险。
- 基于ARM的嵌入式系统中从串配置FPGA的实现(06-09)
- 周立功:如何兼顾学习ARM与FPGA(05-23)
- 初学者如何学习FPGA(08-06)
- 为何、如何学习FPGA(05-23)
- 学习FPGA绝佳网站推荐!!!(05-23)
- 我的FPGA学习历程(05-23)
