多维设计技术力促3D芯片
时间:05-02
来源:互联网
点击:
从绑定线转变到硅通孔能使互连密度更高,还能帮助设计师脱离矩形的“农场地”框框的束缚,使他们在设计芯片版图时更像是在设计电路板。没有电路的区域可以用于其它结构,例如垂直互连总线甚至用于冷空气的烟道。异质3D堆叠式裸片还能达到新的集成度,因为整个系统可以组合成单个硅块。
“3DIC带来的最重要影响是远离农场式设计的机会,这种农场式设计是将每个芯片分割成相邻且完全拼接式的矩形块。”Doherty指出,“与用光芯片上的所有面积不同,3D芯片设计师可以从裸片上切割出方形、三角形和圆形进行垂直互连,并很好地释放出热量。”
“3D技术可以给芯片设计带来许多新的想法。设计师必须采用不同的思维方式,以创新的方式组合他们的CPU、内存和I/O功能,这是每样东西只能在邮票大小的面积上并排放置的方法所不能做到的。”
有许多半导体协会都在研究制订3D技术标准。国际半导体设备与材料组织(SEMI)有4个小组专攻3DIC标准。其三维堆叠式集成电路标准委员会包括SEMI成员Globalfoundries、惠普、IBM、Intel三星和UnitedMicroelectronicsCorp.(UMC)以及Amkor、ASE、欧洲的校际微电子中心(IMEC)、亚洲的工业技术研究院(ITRI)、奥林巴斯、高通、Semilab、东京电子和赛灵思公司。
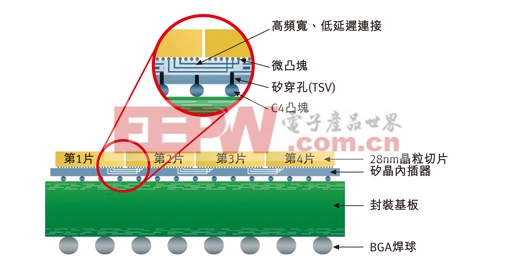
图1:赛灵思公司组合运用硅通孔和受控塌陷芯片连接焊球在台积电生产的硅中介层上安装4个FPGA。(图片来源:赛灵思)
更多资讯请关注:21ic模拟频道
- 先进3D芯片堆叠的精细节距微凸点互连(05-27)
- 采用高级设计技术来减少IC功耗(10-29)
- 12位串行A/D转换器MAX187的应用(10-06)
- AGC中频放大器设计(下)(10-07)
- 低功耗、3V工作电压、精度0.05% 的A/D变换器(10-09)
- PIC16C5X单片机睡眠状态的键唤醒方法(11-16)
