面对EUV光刻技术,芯片制造商如何权衡复杂分类
信。
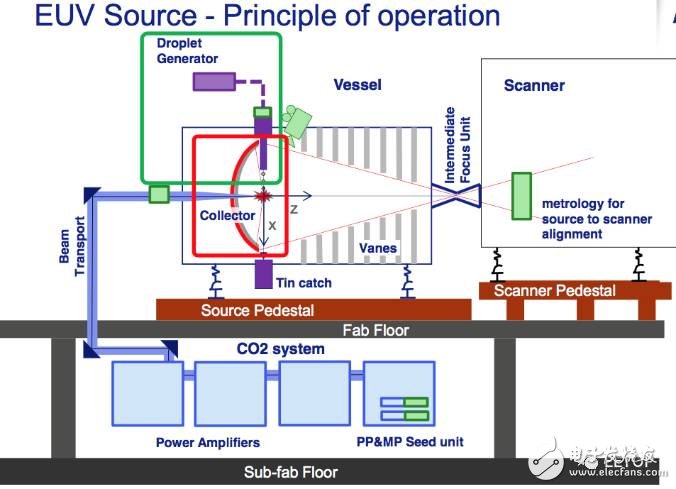 图3:该EUV的复杂性。来源:ASML
图3:该EUV的复杂性。来源:ASML
在EUV中,电源将等离子体转换成13.5nm波长的光。 然后,光反弹了10个多层镜子的复杂方案。
在这一点上,光通过可编程照明器并击中面罩。 从那里,它会弹出六个多层镜子,并以6%的角度击中晶片。
 图4:准确弹跳光 来源:ASML /Carl Zeiss SMT Gmbh
图4:准确弹跳光 来源:ASML /Carl Zeiss SMT Gmbh
最大的挑战是电源。它不会产生足够的电源或EUV光,以使EUV扫描仪能够足够快,或使其经济可行。
为了使EUV进入HVM,芯片制造商需要能产生250瓦功率的EUV扫描器。这转化为每小时125瓦的吞吐量(wph)。
实现这些目标所花费的时间比预期的要多。不久前,源产生的功率只有10瓦。然后,ASML的电源从80瓦特移动到125瓦特,将EUV的吞吐量从60瓦特提高到85瓦特。
今天,ASML正在准备首款生产的EUV扫描仪NXE:3400B。该工具的数值孔径为0.33,分辨率为13nm。 ASML高级产品经理Roderik van Es表示:"如果您看系统的成像性能,我们(已完成)13nm LS和16nm IS。 (LS是指线和空间,而IS是隔离线。)
最初,该工具将装载一个140瓦的源,实现100瓦的吞吐量。最近,ASML已经展示了一个250瓦的来源。根据Es的说法,这个250瓦特源的工业化版本将在年底前发布。
即使是250瓦的光源,但是平板印刷师担心系统的正常运行时间。 今天的193nm扫描仪可以不间断地在制造厂以250W或更快的速度运行。 相比之下,预生产的EUV机器的上升时间却在70%和80%左右。
Stifel Nicolaus Ho表示:"可用性或工具在需要停机维护之前可以运行多长时间,仍然是一个令人担忧的问题,特别是对于英特尔来说。 如果希望90年代高可用性指标的英特尔公司,则可用性水平不能达到70%甚至80%。"
不过还有待观察的是NXE:3400B在现场表现如何。 如果仍然存在正常运行时间问题,平板电脑正在研究为冗余目的购买额外的工具的想法。
那当然,这是一个昂贵的提议,芯片制造商宁愿避免。 分析师表示,每个EUV扫描仪售价约为1.25亿美元,而今天的193nm浸没式扫描仪则为7000万美元。
阻抗的问题
多年来,EUV的首要挑战是电源。现在最大的挑战是从源头转移到涉及抗蚀剂的过程。
EUV可分为两大类:化学放大抗蚀剂(CAR)和金属氧化物。 CAR在业界使用多年,利用基于扩散的过程。较新的金属氧化物抗蚀剂基于氧化锡化合物。
所谓的抵抗力也涉及所谓的RLS三角分辨率(R),线边粗糙度(LER)和灵敏度(S)之间的三个指标之间的折衷。
为了达到所需的分辨率,芯片制造商希望以20mJ / cm 2的灵敏度或剂量进行EUV抗蚀。这些抗蚀剂是可用的,但它们比以前想象的更难加入HVM。
"在32nm间距和以下,无论何种剂量,无论CAR还是金属氧化物,无论如何,至少在理由范围内(<100mJ /cm²),"GlobalFoundries Levinson说。
然而,该行业已经开发出在30mJ / cm 2和40mJ / cm 2工作的EUV抗蚀剂。基于RLS三角形的原理,较高剂量的抗蚀剂提供更好的分辨率。但是它们较慢并影响了EUV的吞吐量。
采用30mJ / cm 2的剂量,根据ASML,具有250瓦特源的EUV扫描仪的吞吐量约为104-105Wph,不含防护薄膜,低于期望的125wph目标。
Levinson说:"现有的EUV抗蚀剂能够支持7nm HVM,但是随着我们走向更小的CD,我们脱离了悬崖。" "下一个节点可能处于危险之中,因为耗时少的抗氧化剂时间过长。"
这是关于在20mJ / cm 2下开发抗蚀剂的时间和金钱。该行业正在开发针对5nm的抗蚀剂。
抗拒挑战是艰巨的。 Lam Research的技术总监Richard Wise在最近的一次活动中说:"剂量不一定是我们想要的。" "由于EUV的随机效应,降低剂量有很多根本的身体挑战。"
随机指标是随机变化的另一种方式。光是由光子制成的。 Fractilia首席技术官Chris Mack解释说,暴露少量抗蚀剂的光子数量与所需的曝光剂量相对应。 "但是这个平均值有随机变化。如果曝光该抗蚀剂体积的光子数量较多,则相对随机变化较小。但是,随着曝光少量抗蚀剂的光子数量变小,该数量的相对变化就会变大。
这种效应称为光子散粒噪声。散粒噪声是光刻过程中光子数量的变化。
所有类型的光刻受到随机性的影响,但是对于EUV而言更糟。"首先,EUV光子比193nm光子携带能量的14倍。所以对于相同的曝光剂量,有14倍的光子,"麦克说。 "其次,我们正在努力通过使用低曝光剂量来提高EUV扫描仪的吞吐量。这也意味着更少的光子。光子越少,光子或射击噪声就会有很大的随机不确定性。"
光子数量的变化是有问题的。 "我们有更高能量的光子,但还不够。因此,我们有线宽粗糙度和线边粗糙度(图案),"TEL技术人员资深成员
- 大数据解决方案,布局智能安防(07-04)
- 基于英特尔技术的几大汽车创新设计(06-15)
- 四大案例让你了解最先进的物联网网关解决方案(04-08)
- 物联网网关四大案例解决方案(11-21)
- 物联网应用实例(02-23)
- 相比VR/AR 英特尔的MR不过时?(07-18)
