BIST在SoC片上嵌入式微处理器核上的应用
BIST在SoC片上嵌入式微处理器核上的应用
引 言
随着科技的不断发展,集成电路的制造工艺和设计水平得到了飞速提高,设计者能够将非常复杂的功能集成到硅片上。将PCB板上多块芯片的系统集成到一块芯片内部,这个芯片就是系统级芯片,即SoC(System on Chip)。SoC芯片的特点主要有两方面:第一是其高度的复杂性,第二是大量运用可重用的IP(Intellectual Property)模块。以往的芯片设计往往只专注于某个特定功能的模块设计,例如压缩/解压、无线模块、网络模块等。而一块SoC芯片的功能可能是多个独立模块的总和。另外,芯片的制造需要经历化学、冶金、光学等工艺过程,在这些过程中可能引入物理缺陷导致其不能正常工作。因此对芯片的测试成为必不可少的环节。可测性设计(Design ForTest,DFT)是在芯片的设计阶段就考虑以后测试的需要,使芯片测试更加容易和充分,并降低测试成本。一个SoC包含各种可复用的功能IP核,其中嵌入式微处理器核是其中的关键部分,大部分都嵌有一个或多个微处理器核以获得最好的性能。所以,对微处理器核可测性问题的研究越来越迫在眉睫。
1 传统测试方法
20世纪七八十年代之前,集成电路还都是小规模电路时,测试大都通过加入激励,探测相应的方式来完成。这种方式在电路规模不大并且频率不快的情况下还是可行的,但是随着集成电路规模的增长,功能验证内容增多,或者需要使用异步激励信号时,这样的测试方式就存在局限性。为了提高故障点的测试覆盖率,出现了自动向量生成(ATPG)工具。运用ATPG算法以及强大的计算机,可以检测到尽可能多的故障点。随着芯片规模的增长,芯片门数相对于引脚数目的比例变得太悬殊,只通过输入/输出引脚进行测试的方法几乎不能再应用了,于是出现了另外一种基于扫描的测试技术——DFT。但当扫描链很长而且数量很多时,单芯片测试时间还是很长。同时高级测试仪器的价格急速攀升,使得BIST(Built-In Self-Test)即片内测试方法的产生成为必然。
2 几种常用的BIST方法及其优缺点
片内测试是节省芯片测试时间和成本的有效手段,外部测试的测试速度以每年12%的幅度增长,而片内芯片的速度以每年30%的幅度增长,这一矛盾进一步推动了BIST的应用。由于SoC芯片内部的IP种类繁多,对不同的IP核采用不同的BIST测试方法。采用BIST技术的优点在于:降低测试成本、提高错误覆盖率、缩短测试时间、方便客户服务和独立测试。目前BIST测试方法主要有MemBIST和LogicBIST。
2.1 MemBIST
MemBIST是面向嵌入式芯片存储器的测试方式,用于测试存储器工作是否正常。芯片内部有一个BISTController,用于产生存储器测试的各种模式和预期的结果,并比较存储器的读出结果和预期结果。MemBIST可分为RAMBIST和ROMBIST。目前较常用的存储器BIST算法有March算法及其变种。业界常用的工具有Mentor Graphics的MBIST Architecture。
2.1.1 RAMBIST测试结构
用RAM实现的数据Cache和指令Cache均使用普通的BIST方法。因为这两个RAM的结构完全相同,因此为了减少面积消耗,只使用一组测试电路。在测试时有外部信号TE0、TE1分别控制RAM1、RAM2是否处于测试状态,TE0、TE1不能同时有效。测试电路结构如图1所示。
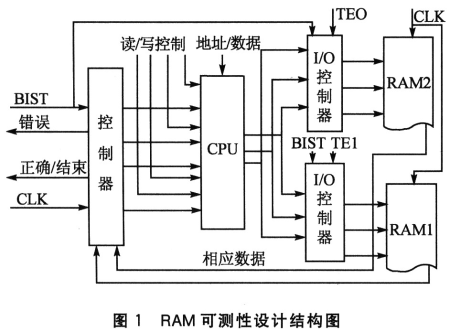
控制器在外部输入信号BIST的控制下,产生读写控制信号、访问地址和测试码,对RAM的相应数据进行压缩分析,并将得到的特征值与存放在芯片中的标准特征值比较。通过两个I/O口报告测试结果,还实现了初步的故障诊断功能。当发现有故障时,通过TAP控制器,可以将出错的地址移出芯片,为进一步的故障诊断和修复提供信息。
2.1.2 ROMBIST测试结构
通常使用循环冗余校验(CRC)电路实现ROM的测试,这种方法虽然测试结果很可靠,但是需要逐位读取信息,而对ROM的访问是每次32位,如果使用该方法则需要一个缓冲机制,并且速度会很慢。在此仍使用RAM测试中并行的数据压缩,故障覆盖率能够达到要求,测试电路也比CRC电路简单。测试电路如图2所示。
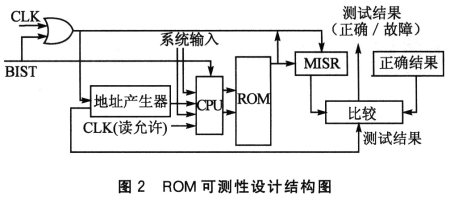
BIST测试信号由TAP控制器的TDT口输入,是整个测试电路的使能信号,测试过程经过触发后,完全在电路内部完成,结束后通过一个I/O口报告测试结果。多输入寄存器(MISR)作为TAP控制器的数据寄存器,测试初始化时设置为初始状态。
2.2 LogicBIST
LogicBIST方法是利用内部的向量产生器逐个地产生测试向量,将它们施加到被测电路上,然后经过数字压缩和鉴别产生一个鉴别码,将这个鉴别码同预期值进行比较。
LogicBIST通常用于测试随机逻辑电路,
- 用于移动微处理器的高性能、集成化电源 IC:并非仅适合便携式设备(08-23)
- 善用微处理器简化电源供应器设计(10-25)
- 可编程和宽输入电压电池充电器的设计方案(03-13)
- 如何轻松达成汽车功能的安全性?(05-07)
- 基于LPC2119的自主式移动机器人设计(04-30)
- 云计算+大数据:下一个系统设计关键所在(10-19)
