传感器有望挑战更小尺寸,全因这个技术
晶圆代工领导厂商提供3D中介层技术,这些技术通常是基于0.18μm模拟专业制程,具有各种制程模块,例如金属绝缘层金属电容(MIM cap)、高阻值多晶硅电阻(Poly resistor)、最多六个金属层、厚顶金属电感(Thick top metal)等,还有更多。 主动中介层具有正面和背面接垫,前侧接垫可用于组装/堆栈任何种类的晶方,例如传感器或MEMS组件,背面接垫则主要用于电路板层级的整合(图4)。 提供各种尺寸闸球和间距的WLCSP技术是由晶圆厂提供的额外服务。 另一个选择是,背面的接垫可以用于将更远的芯片附着于底部。
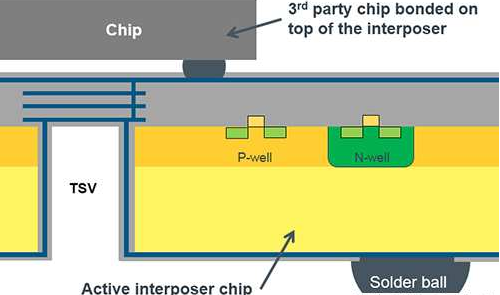
图4 接合在主动3D硅中介层顶部的第三方芯片。
设计套件整合加速开发时程
领先的模拟晶圆代工业者确实为IC开发提供了设计环境。 理想而言,一些极少的产业基准制程开发工具包(PDK)确实能提供创建复杂的混合讯号设计所需的全部建构区块,而这些设计是基于专业晶圆代工业者的先进晶圆制程技术,并且适用于所有主要的先进CAD环境。
透过些微的修改,已经建立了3D积体参考设计流程,这让设计者得以对3D积体IC系统进行全部功能和物理的验证。 PDK有助于针对裸片尺寸、效能、良率和更短的上市时间实现更有效的设计,并为产品开发人员提供一个「首次就正确」设计的可靠途径。
改善尺寸/降低物料成本 3DIC技术发展潜力佳
3DIC技术广泛用于内存IC、影像传感器及其他组件的堆栈,并且已经在数字世界成功获得证明。 在模拟和混合讯号主导的应用中,为客户提供先进的3DIC技术,这是晶圆代工业者所面临的主要挑战。
藉由缩小TSV直径、减少TSV间距,并与晶圆级芯片尺寸技术结合,3D系统架构得以能够取代传统2D系统级封装解决方案。 3DIC概念,例如接垫替代技术或主动中介层将大幅改善系统的外形尺寸、提高效能,并有助降低物料列表成本,这是物联网领域中所有行动设备、穿戴式装置或智能传感器装置的关键所在。
更多最新行业资讯,欢迎点击《今日大事要闻》!
- 传感器和致动器正成为元器件市场新热(03-12)
- 图像传感器市场突破60亿美元,CMOS将占主导地位(05-22)
- 超低功率“智能尘埃”创新无限,无线传感器技术继续高歌猛进(05-22)
- 电化学气体传感器核心技术见突破(05-26)
- 日本工业机器人选中Cognex视觉传感器作为标准组件(04-14)
- 欧姆龙索能发力通用传感器市场,上海成立合资公司(05-08)
