传感器有望挑战更小尺寸,全因这个技术
系统工程师在开发复杂的电子产品,例如传感器和传感器接口应用时,他们所面临的重大挑战为更小的外形尺寸、杰出的功能、更佳的效能及更低的物料列表成本(BoM)。 设计者可以采用具有较高整合密度的较小制程节点来缩减晶方尺寸,同时也能使用先进的封装技术来实现系统小型化。
3DIC成为缩小传感器IC新解方
对于更高系统整合度的需求持续增加,这不只促使传统的组装服务供货商,也推动半导体公司开发更创新和更先进的封装技术。 最具前景且最具挑战性的技术之一就是采用硅通孔(TSV)的三维积体(3DIC)。 3DIC技术现在已被广泛用于数字IC(例如,内存IC、影像传感器和其他组件的堆栈)中,其设计和制造方法已经在数字世界中获得成功证明。 接下来,设计者要如何将3DIC技术成功导入以模拟和混合讯号为主的的传感器IC中?
在今日,走在前面的模拟和混合讯号IC开发商已开始意识到采用模拟3DIC设计的确能带来实质好处。 智能传感器和传感器接口产品锁定工业4.0、智能城市或物联网(IoT)中的各种应用。 在各种芯片堆栈技术中,TSV和背面重新布局层(BRDL)可用来替代传统金线接合,此技术的用处极大。
3D积体技术,特别是来自领导晶圆代工业者的特殊模拟TSV技术,在结合正面或背面重新布局层(RDL)后,由于互连更短且能实现更高的整合度,因此能以更小的占板面积提供更多功能。 特别是小尺寸的TSV封装技术(总高度在0.32mm范围内)能解决智能手表或智能眼镜等穿戴式装置的的小尺寸需求。
在不同的芯片或技术组合中,TSV技术还能提供更高水平的灵活度,例如采用45奈米制程的数字芯片中的芯片至芯片堆栈,以及在模拟晶圆(例如180nm)中,微机电(MEMS)组件或光传感器和光电二极管数组的堆栈,这只是其中的几个例子。
模拟3DIC技术通常是透过建造芯片正面到IC背面的电气连接来实现传感器应用。 在许多传感器应用,例如光学、化学、气体或压力传感器中,感测区域是位在CMOS侧(晶圆的顶端)。 芯片和导线架之间最常用的连接是打线接合(Wire bonding)(图1)。 无论是使用塑料封装,或是将裸片直接接合在印刷电路(PCB)或软性电路板上,对于某些会将感测区域暴露出来的应用而言,打线接合并非理想的解决方案。 采用专业晶圆代工业者的专有TSV技术,可以利用TSV、背面RDL和芯片级封装(WLCSP)(图2)来替代打线。
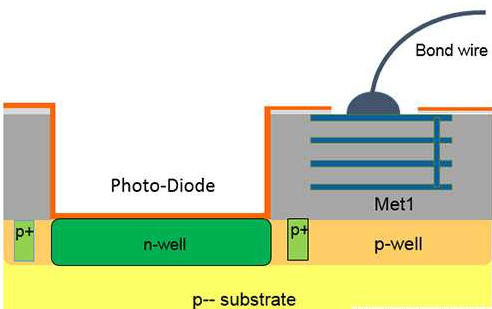
图1 采用标准打线接合的传感器芯片。
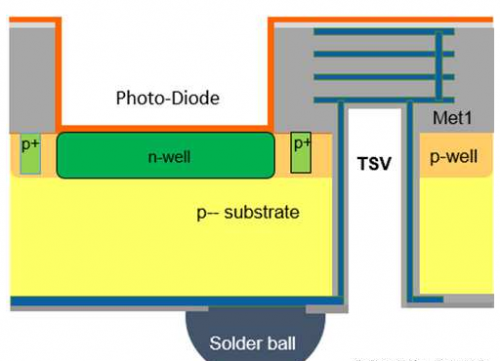
图2 采用TSV背面连接的传感器芯片。
打造新3D应用/替换晶圆接垫新一代硅通孔技术妙用多
类似于半导体技术,新的制程技术是透过使用更小的几何形状和设计规则(摩尔定律)提供更高的效能和更高的积体密度,下一世代的TSV技术将优于当前可用的3DIC技术。 一些专业晶圆代工业者正在开发下一世代TSV技术,其直径(约40μm)将大幅缩小,因此能提供更小的间距和更高的密度,同时提供相同或甚至更好的模拟效能。 这种下一代TSV技术是新3D应用的基础,晶圆代工业者正在开发提供全新服务,像是所谓的「第三方晶圆上的接垫置换(Pad Replacement on 3rd Party Wafer)」或「主动3D中介层(Active 3D Interposer)」等。
另外,直径和间距更为缩减的下一世代TSV技术,将能够透过结合背面RDL和晶圆级芯片尺寸封装(WLCSP的)TSV,也就是所谓的3D-WLCSP来替换任何已经处理和完成的晶圆的接垫(Pad)。 即使在制造过程完成后,客户也能够灵活地决定产品是否应在正面进行打线接合,或者在背面使用WLCSP技术进行凸块封装。 这种新技术概念允许在任何芯片,甚至是在第三方芯片上处理TSV,做为后处理步骤之一(后钻孔概念)。 在TSV开发方式中,其直径和最小间距能极佳地匹配第三方芯片所采用制程的接垫需求(图3)。
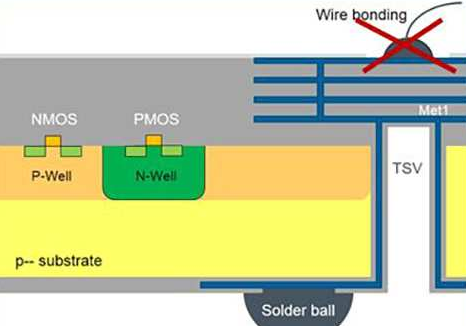
图3 打线接合将被TSV与WLCSP(= 3D-WLCSP)的组合所取代。
硅中介层为3DIC创新技术
3DIC技术的另一个变化和极为创新的发展,是硅中介层架构(Silicon interposer architecture)。 所谓的被动3D硅中介层是用来产生一个从芯片的顶端到底部的简单电气连接。 所谓的主动3D硅中介层能支持实现完整CMOS设计所需制程技术的所有被动和主动组件。
晶圆代工领导厂商提供3D中介层技术,这些技术通常是基于0.18μm模拟专业制程,具有各种制程模块,例如金属绝缘层金属电容(MIM cap)、高阻值多晶硅电阻(Poly resistor)、最多六个金属层、厚顶金属电感(Thick top metal)等,还有更多。 主动中介层具有正面和背面接垫,前侧接垫可用于组装/堆栈任何种类的晶方,例如传感器或MEMS组件,背面接垫则主要用于电路板层级的整合(图4)。 提供各种尺寸闸球和间
- 传感器和致动器正成为元器件市场新热(03-12)
- 图像传感器市场突破60亿美元,CMOS将占主导地位(05-22)
- 超低功率“智能尘埃”创新无限,无线传感器技术继续高歌猛进(05-22)
- 电化学气体传感器核心技术见突破(05-26)
- 日本工业机器人选中Cognex视觉传感器作为标准组件(04-14)
- 欧姆龙索能发力通用传感器市场,上海成立合资公司(05-08)
