苏州纳米所在GaN HEMT器件研究上取得进展
由于GaN具有大禁带宽度、高电子迁移率、高击穿场强等优点,GaN HEMT成为新一代功率器件研究的热点。由于极化作用,AlGaN/GaN异质结界面会形成高浓度的二维电子气,浓度可达到1013/cm2量级,因此一般的GaN HEMT都是耗尽型器件。如何实现增强型GaN HEMT一直是该领域研究的难点,目前几种主要用来制备增强型器件的方案包括:p型栅、凹槽栅、F处理和Cascode结构。其中,p型栅的方案已经被很多著名的研究机构和公司采用,如IMEC、FBH、Panasonic、EPC和Samsung等。但是制备这种器件结构需要对几十nm的p-GaN层进行刻蚀,由于刻蚀工艺的特点,对粗糙度、均匀性、选择性、腔室控制等方面提出了挑战,容易造成刻蚀不均匀和刻蚀损伤的问题。
针对上述问题,中国科学院苏州纳米技术与纳米仿生研究所研究员张宝顺课题组提出一种新的实现增强型p-GaN 栅结构AlGaN/GaN HEMT的工艺技术——H等离子体钝化p-GaN技术。这种技术是通过H等离子体将p-GaN中的浅能级受主杂质Mg钝化成Mg-H中性复合物,从而将p型GaN转化成高阻的GaN,这种高阻GaN将截断器件中p-GaN的漏电通道,提高栅控制能力,同时由于p-GaN中的Mg受主被钝化,释放了钝化区下方的原先被p-GaN耗尽的沟道电子。H对于浅能级受主杂质有很强的钝化作用,但对于施主杂质的影响很小,这使得H对于p-GaN/AlGaN具有一定的选择性,因此这种工艺技术具有很好的工艺窗口。不同于刻蚀工艺去除栅下以外的p-GaN盖帽层,H等离子体技术将栅下以外的p-GaN盖帽层变为高阻的GaN,保留下来的厚的高阻GaN有利于降低器件的电流崩塌。目前采用H等离子体技术实现的p-GaN 栅结构AlGaN/GaN HEMT的阈值电压可以达到+1.75 V,饱和电流200mA/mm,开关比107。通过变温测试,这种工艺的可靠性也得到了初步的验证。该科研成果发表在《应用物理快报》(Applied Physics Letters,DOI: 10.1063/1.4964518)上。
上述研究工作得到了国家重大科学仪器设备开发项目等的大力支持。
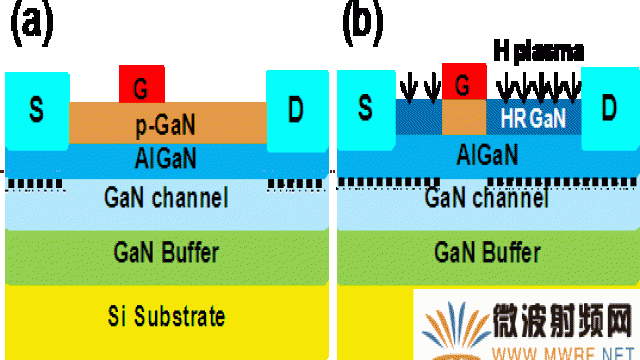
图1.(a)H等离子体处理前器件结构(b)H等离子体处理后器件结构。
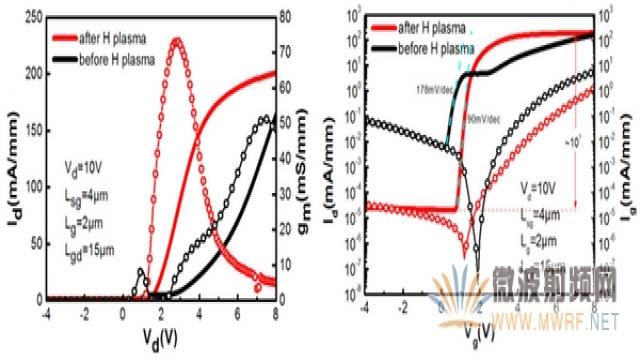
图2. H等离子体处理前后器件性能变化,左为线性坐标,右为对数坐标。
- TriQuint推出最新GaN解决方案实现功率和效率(11-08)
- TriQuint推出具卓越增益的GaN晶体管(12-18)
- 预计2019年微波射频半导体市场规模超3亿美元(12-19)
- Qorvo 宣布 2 亿美元股份回购计划(02-16)
- Qorvo?将成为射频解决方案领域的全新领导者(03-03)
- 全新Qorvo借CCBN在中国市场启航(05-18)
