冲电镀。由于1μm的Cu电镀层太薄,镀层受到较强基体效应的影响,电沉积条件对晶面的影响很小,因此籽晶层的晶面在很大程度上决定了镀层的晶面情况。有文献报道,当Cu镀层超过4μm后,就基本不受基体外延的影响,而主要由电沉积条件决定,形成绝对优势的择优晶面取向。
2.3 AFM测量结果
图3为脉冲电镀与直流电镀电沉积Cu镀层表面粗糙度RMS(rootmeansquare)与电流密度的关系。可见脉冲所得镀层表面粗糙度仅为几个纳米,而直流所得镀层表面粗糙度在10nm以上,最大时甚至达到了40nm,这样大的粗糙度将为后续CMP工艺造成极大的困难。而平整的表面可以为CMP工艺提供一个易于进行处理的基底表面,采用脉冲电镀Cu镀层的表面粗糙度RMS比直流电镀的低。
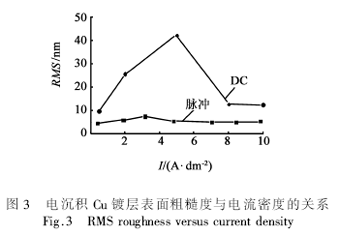
2.4 SEM测量结果
图4为脉冲电镀与直流电镀电沉积Cu镀层的SEM照片。由于有机添加剂将极大地影响Cu晶粒的生长过程,为了单独考察电沉积条件对晶粒生长的影响,SEM测量的是在没有三种添加剂情况下得到的镀层。可见在相同的电流密度下,脉冲所得镀层的表面晶粒密度远大于直流。之所以会出现这样的差别,原因在于脉冲关断时间虽然对电镀效率没有贡献,但它并不是一个"死时间"。在关断周期内可能发生一些对电结晶过程很有影响的现象,如重结晶、吸脱附等。在关断时间内,晶粒会长大,这是由于晶粒在关断时间内发生了重结晶现象。从热力学规律可知,晶粒越大越稳定。集成电路芯片互连中通常需要较大尺寸的晶粒,因为大尺寸晶粒的晶粒边界较少,偏折电子的几率较小,相应的电阻系数也较小,抗电迁移能力也更强[11]。

3 结语
本文研究了脉冲电镀和直流电镀所得Cu镀层电阻率、织构系数、晶粒大小和表面粗糙度等特性参数。实验结果表明,在相同电流密度条件下,脉冲电镀所得Cu镀层电阻率较低、表面粗糙度较小、表面晶粒尺寸和晶粒密度较大,而直流电镀所得镀层(111)晶面的择优程度优于脉冲。脉冲电镀对电沉积过程有着更强的控制能力,能降低浓差极化,改善镀层物理性能,获得致密的低电阻率金属电沉积层,所得镀层在很多性能方面优于直流电镀。在超大规模集成电路Cu互连技术中,脉冲电镀将有良好的研究应用前景。
|
|