BGA元件的维修技术及操作方法
球栅列阵封装技术(Ball Gird Arroy),简称BGA封装早在80年代已用于尖端军备、导弹和航天科技中。
随着半导体工艺技术的发展,近年来在手机亦广泛地使用到BGA封装IC元件,它对于手机的微型化和多功能化起到决定性作用。但是,手机制造商却同时利用BGA元件的难维修性,人为加进某些限制来制约手机维修业界,使我们在维修BGA过程中碰到一定的困难,甚至无从下手。笔者从事电子通讯维修十年,并对SMD元件的焊接、解焊设备略有琢磨,籍此向同行介绍BGA元件的维修技术与操作技能,望能以"抛砖引玉",将技术提高到更高层次。
一.BGA维修中要重视的问题
因为BGA封装所固有的特性,因此应谨记以下几点问题:
①防止焊拆过程中的超温损坏。
②防止静电积聚损坏。
③热风焊接的风流及压力。
④防止拉坏PCB上的BGA焊盘。
⑤BGA在PCB上的定位与方向。
⑥植锡钢片的性能。
BGA在PCB板上的装联焊接本是电子工厂自动化设备进行的,业余情况下碰到上述的问题虽有难度,但凭着细心、严谨、科学的态度,借助先进的返修设备工具,操作容易、成功率是较大的。
二. BGA维修中要用到的基本设备和工具
BGA维修的成败,很大程度上决定于植锡工具及"热风枪"。笔者及很多同行碰到最多的难题还是植锡困难和"850"操作温度和风压"无谱",就算采用"白光"850热风枪也都会因电压变动的原因,温度和气流也很难掌握,不知不觉中损坏BGA和主板,因此成功率不高。笔者从维修设备市场几经筛选,从精度、可靠性、科学性角度最终还是选用了以下的设备和工具(如下图):
① SUNKKO 852B 智能型热风拆焊器。
② SUNKKO 202 BGA防静电植锡维修台。
③ SUNKKO BGA专用焊接喷头。
④ SUNKKO 3050A 防静电清洗器。
而真空吸笔、放大镜(显微镜更好)则作为辅助使用。

三. BGA的维修操作技能
⑴.BGA的解焊前准备。
将SUNKKO 852B的参数状态设置为:温度280℃~310℃;解焊时间:15秒;风流参数:×××(1~9档通过用户码均可预置);(如下图)

最后将拆焊器设到自动模式状态,利用SUNKKO 202 BGA 防静电植锡维修台,用万用顶尖将手机PCB板装好并固定在维修台上。
⑵.解焊。
解焊前切记芯片的方向和定位,如PCB上没有印定位框,则用记号笔沿四周划上,在BGA底部注入小量助焊剂,选择合适被解焊BGA尺寸的BGA专用焊接喷头装到852B上,



将手柄垂直对准BGA,但注意喷头须离开元件约4mm,按动852B手柄上的启动键,拆焊器将以预置好的参数作自动解焊。

解焊结束后在2秒后用吸笔将BGA元件取下,这样可使原锡球均匀分在PCB和BGA的焊盘上,好处是便于续后的BGA焊接。如出现PCB焊盘上有余锡搭连,则用防静电焊台处理均匀,严重的搭连,可以PCB上再涂一次助焊剂,再次启动852B对PCB加温,最终使锡包整齐光滑。通过防静电焊台采用吸锡带将BGA上的锡完全吸除。注意防静电和不要过温,否则会破坏焊盘甚至主板。
⑶.BGA和PCB的清洁处理。
使用高纯的洗板水将PCB焊盘清洁擦净,采用超声清洗器(要带防静电装置)装入洗板水,将拆下的BGA进行清洗干净。
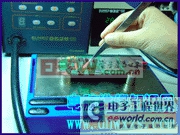


⑷.BGA芯片植锡。
BGA芯片的植锡须采用激光打孔的具有单面喇叭型网孔之钢片,钢片厚度要求有2mm厚,并要求孔壁光滑整

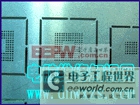
齐,喇叭孔的下面(接触BGA的一面孔)应比上面(刮锡进去小孔)大10μm~15μm。(上述两点通过十倍的放大镜就可以观察出)。这样才能使漏印而锡浆容易落到BGA上,要注意现市场上较多的劣质钢片都不是激光加工的,而是化学腐蚀法,它除了孔壁粗糙不规则,网孔没有喇叭形或出现双面喇叭孔,这类钢片在植锡时碰到的困难就很大了。采用上述的BGA维修台中之植锡功能→模板和钢片,先在定位模板找到相应的凹位,将BGA元件用双面
胶粘到凹槽内,将带有精密定位方、圆孔的钢片放到定位模板上,再用其附件磁力压块将钢片压贴模板上。由于该套工具独特的三重精密定位装置(BGA→模板→钢片),保证就算闭上眼亦能将钢片网孔很方便、很准确地对准BGA元件小焊盘(但切记钢片刻有字的为向上)。用小刮刀将小量的、较浓稠的锡浆刮到钢片的网孔里,当所有网

孔已充满后,从钢片的一端将钢片慢慢地掀起,BGA芯片

上即漏印出小锡堆,再次用拆焊器如前述对其加温,使BGA上锡堆变成列阵均匀的锡球。如个别焊盘未有锡球,可再压上钢片进行局部补锡。笔者不赞同连钢片一起加温的办法,因为这样除影响植锡球外,还会将精密的钢片热变形而损坏。
⑸.BGA芯片的焊接。
在BGA锡球和PCB焊盘上沾上小量较浓的助焊剂(要求高纯,可采用活性松香加入到分析纯酒精中溶解出),找回原来的记号放置BGA。助焊的同时可对BGA进行粘接定位,防止被热风吹走,但要注意不能放太多焊剂,否则加温时亦会由于松香产生过多的气泡使芯片移位。PCB板同样亦是安放于防静电维修台中用万用顶尖固定并须水平安放。将智能拆焊器参数预设为温度260℃~280℃,焊接时间:20秒,气流参数不变。BGA喷咀对准芯片并离开4mm时,触发自动焊接按钮。随着BGA锡球的熔化与PCB焊盘形成较优良的锡合金焊接,并通过锡球的表面张力使芯片即使原来与主板有偏差亦会自动对中,如此大功告成。注意焊接过程中不能对BGA进行施压力,哪怕风压太大亦会使BGA下面锡球间出现短路。
模拟电路 模拟芯片 德州仪器 放大器 ADI 模拟电子 相关文章:
- 12位串行A/D转换器MAX187的应用(10-06)
- AGC中频放大器设计(下)(10-07)
- 低功耗、3V工作电压、精度0.05% 的A/D变换器(10-09)
- PIC16C5X单片机睡眠状态的键唤醒方法(11-16)
- 用简化方法对高可用性系统中的电源进行数字化管理(10-02)
- 利用GM6801实现智能快速充电器设计(11-20)
