半导体器件的电气过应力和静电放电故障
能故障。EOS比ESD的进程要慢得多,但相关能量却很高。热损坏是EOS事件期间生成过多热量造成的结果。EOS事件的高电流会在低电阻路径中生成局部高温。高温会造成栅氧化层、互联、金属烧毁等器件物质损坏。一般说来,EOS和ESD被归为一种故障机制,即“ESD和EOS故障”。这是因为EOS和ESD故障模式很像。ESD和EOS的过应力事件很像,但电流或电压以及时间过应力条件不同。ESD电压很高(>500V),峰值电流一般(~1A到10A),发生时间很短。EOS的电压较低(100V),峰值电流很高(>10A),发生时间较长。如闩锁效应长期持续,也会造成EOS损坏。
静电放电(ESD)
ESD是指两个具有不同静电电势物体之间通过直接接触或感应电场而发生瞬态静电放电。ESD是静电带电物体通过IC静电放电导致较大电流和能耗的结果,进而损坏IC。任何物质表面的电荷通常是中性的,如传递能量,就会出现电荷不平衡。
导体由于导电表面较高的电子流动性不太容易带电,因此会出现电荷重组并保持中性表面。另一方面,摩擦很容易让绝缘体带电。传递能量到不导电物质上就会积累大量局部电荷,最终通过外部路径进行放电。静电的主要来源就是绝缘体,如塑料表面、绝缘鞋、木材、泡沫包装等。由于绝缘体的电荷分布不均匀,因此其生成的电压会非常高(kV)。
此外,IC的ESD损坏也是热现象。局部体积快速产生大量热,很难消除,这就造成金属互联烧坏、聚酯损坏、栅氧化层破坏、接触破坏、结点破坏等IC损坏。
当人走在合成树脂地板上,生成的电压可能高达20kV。干燥空气中摩擦尼龙和聚酯物质产生的电压可高达25kV。如果此人接触接地物体,电荷会在极短时间(1到100纳秒)内从人体移到该物体上,放电时间和电流具体取决于时间常数。
放电电流约为1到10A。从工厂到现场使用过程中随时都有可能出现电子设备的静电损坏。半导体设备的设计需考虑ESD保护问题,要能在短时间内承受高电流。举例来说,如果设备通过ESD-HBM认证,能承受2kV的规范电压,那么该设备就能在10纳秒的上升时间内承受1.3A的电流,或者在150纳秒的下降时间内承受1.3A电流。不过,该产品不能在几毫秒内承受100mA。如果该产品遭受较弱的ESD脉冲而部分损坏,或许仍能继续工作,并足以通过满足数据表规范要求的量产ATE测试。这个缺陷会随着时间的推移而延伸,几个小时后就会造成产品故障。这种缺陷就是潜在缺陷,由此形成的故障为潜在ESD故障。潜在缺陷难以检测,特别在器件已经装配到成品中的情况下更是如此。
有许多因素都可导致EOS和静电放电(ESD/EOS)产生,譬如欠佳的片上保护电路设计与布局、技术、生产工具、制造和装配工艺、运输以及设计人员电路板设计等现场应用等。设计人员在应用过程中,可能会因瞬变、接地不正确、电源电压与地面之间的低电阻路径、电源引脚或地面短路、内部电路受损等原因出现ESD/EOS现象。对于IC而言,如果其所处环境超出数据表规范,则最终会发生故障。如果IC在数据表规范范围内工作,则其组件的内部条件是不会产生EOS损坏的,因此,EOS损坏只有在条件异常时才会出现。测试和处理设备时如果接地不正确就会积累静电荷,这些电荷在接触IC之后,立即通过IC传递。
ESD测试模型
虽然半导体器件包括EOS保护电路,但是为了确保其满足JEDEC标准规定的有效性和可靠性要求,必须开展ESD测试来检查零部件是否合格。ESD测试主要有3个测试模型:HBM(人体模型)、CDM(充电器件模型)与MM(机器模型)。HBM仿真人体放电产生的ESD。人体被认为是主要的ESD来源,通常采用HBM描述ESD事件。CDM仿真带电器件接触导电物质后放电。MM则仿真物体向组件放电。该物体可以是任何工具,也可以是生产设备。下文会对各个测试模型进行详细描述。
人体模型(HBM)
人在走路时会产生电,但这些电都会进入地面。每走一步都会积累电荷,我们可以采用下列方程式来表示该电荷:ΔV/Δt = n Δq/C,其中,n表示每秒的步伐数,C表示人体电容。请设想一下绝缘地面上的常见情形,结果表明,每走一步ΔV就会增加300V,10秒内达到3kV左右(注:部分电荷泄漏)。
在HBM测试中,我们采用了简单的串联RC网络,如图3所示,用来仿真人体放电。我们使用1MΩ的电阻给100pF电容器充电,然后使用1.5kΩ电阻对其进行放电。大部分HBM事件都是破坏性的,而且上升时间快。因此,采用快速上升时间脉冲可以更加精确地仿真HBM放电事件。
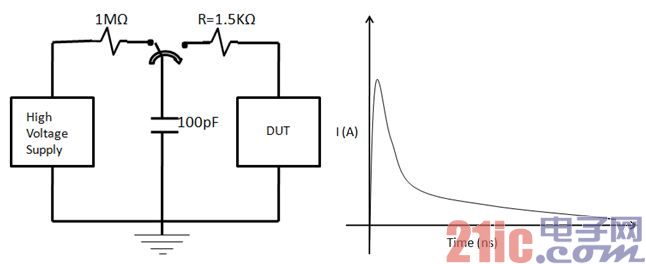
图3:ESD--HBM测试设置与电流波形图

所产生的热量取决于电容、DUT电阻以及ESD脉冲的峰值电压。所产生的热量会引发金属线熔化等热损坏。在HBM
- 太阳能发电系统对半导体器件的需求分析(06-09)
- 柔性非晶硅薄膜太阳电池技术(05-11)
- 未来UPS技术趋势:无变压器技术解析(08-26)
- 12位串行A/D转换器MAX187的应用(10-06)
- AGC中频放大器设计(下)(10-07)
- 低功耗、3V工作电压、精度0.05% 的A/D变换器(10-09)
