低k集成的曙光
时间:10-10
来源:互联网
点击:
随着对新化学品和集成方案了解的加深,我们不但可以减轻介电层孔隙率增加引起的负担还可以降低工艺对超低k薄膜的损伤。
在开发新型超低k(ULK)介电材料的过程中,有两个主要问题一直困扰着业界:ULK材料的孔隙率不断增加,以及工艺集成过程中可能造成的薄膜损伤。本文对这两个问题做了深入探讨,并通过采用基于金属硬掩膜层和新型等离子体化学的集成方案,展示出颇具前景的结果。还介绍了一种特别令人感兴趣的ULK材料:SiOC:H基的有机金属硅酸盐玻璃(OSG)。
1 孔隙率问题
众所周知,介电薄膜中增加的孔隙率对材料的热-机械性能会带来不利的影响。此外,随着孔隙率的增加,材料的弹性模量和导热系数的退化速度(幂指数规律)要比其材料密度和k值的降低速度要快,后两者是以线性规律下降的。然而最近的研究证明,这种衰退能被随后的修复技术所补偿,包括热、等离子体、紫外线和电子束方法,都可以成功地提高材料的热-机械性能。
以紫外线修复为例,紫外线照射以及因此发生的热活化使OSG薄膜中SiOC:H基体的键结构发生重排,从而提高了薄膜硬度,并且保留了薄膜的疏水性和初始的孔隙率。
紫外线修复后材料结构发生重排,大角度的Si-O-Si键向更加稳定的小角或者“网络”结构转变,同时交联程度也得到提高。因此,为了开发最佳的紫外修复工艺,需要深入理解选择性的光分解和基体结构的链迁移率。
2 孔合并
为得到较粗糙的低k薄膜,我们非常希望在没有孔聚集或者联合的情况下降低薄膜密度。然而,当孔隙率增加时,发生孔合并的几率会增加,因此增加了合成新型ULK介电材料的复杂性。
孔合并在许多方面是有害的。直径小于2nm的有序孔,被证明对弹性模量有正面影响,然而那些随机连通的孔会降低机械性能。此外,孔的连通增加了大孔的形成几率,反过来会在铜阻挡层等比例微缩时损害台阶覆盖。最终,孔的连通还会为气体污染物、湿气、湿法清洗化学品、化学机械平坦化(CMP)浆料和用于阻挡层淀积的原子层淀积(ALD)前驱体提供扩散通道,因此需要对其加以控制,使微连通度小于2.0 nm。
3 应用导向
除这些普通的考虑外,低k材料的开发与应用的关系非常密切,往往要满足一些额外的需求。例如,在逻辑器件应用方面,理想的薄膜应该是孔隙率有限的ULK薄膜。然而,当前的开发中,为达到期望的k值,却不得不增加孔隙率。
存储器应用跟随着逻辑器件的路径,并有大约5年的延迟。在这种情况下,低k薄膜必须能经受住较高的电压操作,典型的电压约为15V,并且需要较高的机械性能和超过15GPa的弹性模量。特殊存储器的应用如闪存,根据所采用的工艺而定,可能需要高热稳定性和高场强下的经时绝缘击穿(TDDB)性能。
4 集成方案
铜和低k薄膜的集成变得更加复杂,因为集成工艺对铜电阻系数和有效k值都有影响,在此过程中,工艺参数统计波动的相对重要性持续上升。此外,定义正确方法的难度不可忽视,此方法将问题的基本方面与不完美的工艺分离,因此可能得到对 “互连”的真实评估。对合适的IC后道(BEOL)集成方案来说,选用每种特定的初始材料都需要考虑这些因素。
如果只是纯粹考虑铜大马士革集成中工艺引起的低k膜的损伤,我们知道随着k值的降低,薄膜对物理和化学损伤更加敏感。工艺导致的损伤被证明是集成结构中k值局部增加和/或可靠性降低的原因,这会消弱采用k电介材料的优势。工艺引发的低k膜损伤主要发生在等离子曝光过程中——包括刻蚀、去胶和CMP后等离子体清洗。
5 金属硬掩膜层
特定的材料性质和等离子体造成破坏的程度之间有什么样的关系,目前尚不清楚。在IMEC,主要是通过修改集成方案来减轻刻蚀和去胶等离子体操作导致的电介质退化,其中包括栅叠层选择,等离子体化学的选择,以及刻蚀与去胶的工艺顺序。对于孔隙率小于10%的低k薄膜,应用光刻胶掩膜(RM)集成方案;对于孔隙率比较高的材料,IMEC转向金属硬掩膜(MHM)集成方案(图1)。
按此集成方法,在图形化过程中损伤会达到最小,接下来,CMP和/或铜还原后的CMP后等离子体清洗过程,以及残留的微粒清除过程也可能损伤介电薄膜。
在此前的研究中,研究人员证明了介电材料的机械性质在CMP后缺陷产生过程中扮演重要角色。他们的研究还表明,为减轻CMP导致的机械损伤,提高ULK 薄膜表面的机械性质会是一种可行的方法。因此在MHM淀积之前,沉积一层很薄的SiC层(约5nm)以增强薄膜的机械性能。其他小组用SiO2作为MHM 淀积之前的沉积材料,这一层通常被称为介电保护层(DPL)。MHM方案应用于高孔隙率和中孔隙率的低k薄膜时,其k值(keff)与体材料k值(刚完成沉积)的差异分别减小至0.0和0.2。(集成方案的品质因数是使△k = keff/k尽可能的小。)
将MHM集成方案移植到高孔隙率材料并不容易。金属硬掩膜下的损伤可能会扩展,导致keff的增加和后续湿法清洗中的线条扭曲。这种现象表明,精心选择的刻蚀、去胶和涉及到等离子体参数和工艺顺序的湿法清洗化学品,是决定最优化解决方案的关键。
提高窄线条的图形化性能,包括损伤和线条轮廓控制。接下来的部分将要介绍与低k薄膜有关的等离子体、湿法清洗和CMP工艺的进展。
在开发新型超低k(ULK)介电材料的过程中,有两个主要问题一直困扰着业界:ULK材料的孔隙率不断增加,以及工艺集成过程中可能造成的薄膜损伤。本文对这两个问题做了深入探讨,并通过采用基于金属硬掩膜层和新型等离子体化学的集成方案,展示出颇具前景的结果。还介绍了一种特别令人感兴趣的ULK材料:SiOC:H基的有机金属硅酸盐玻璃(OSG)。
1 孔隙率问题
众所周知,介电薄膜中增加的孔隙率对材料的热-机械性能会带来不利的影响。此外,随着孔隙率的增加,材料的弹性模量和导热系数的退化速度(幂指数规律)要比其材料密度和k值的降低速度要快,后两者是以线性规律下降的。然而最近的研究证明,这种衰退能被随后的修复技术所补偿,包括热、等离子体、紫外线和电子束方法,都可以成功地提高材料的热-机械性能。
以紫外线修复为例,紫外线照射以及因此发生的热活化使OSG薄膜中SiOC:H基体的键结构发生重排,从而提高了薄膜硬度,并且保留了薄膜的疏水性和初始的孔隙率。
紫外线修复后材料结构发生重排,大角度的Si-O-Si键向更加稳定的小角或者“网络”结构转变,同时交联程度也得到提高。因此,为了开发最佳的紫外修复工艺,需要深入理解选择性的光分解和基体结构的链迁移率。
2 孔合并
为得到较粗糙的低k薄膜,我们非常希望在没有孔聚集或者联合的情况下降低薄膜密度。然而,当孔隙率增加时,发生孔合并的几率会增加,因此增加了合成新型ULK介电材料的复杂性。
孔合并在许多方面是有害的。直径小于2nm的有序孔,被证明对弹性模量有正面影响,然而那些随机连通的孔会降低机械性能。此外,孔的连通增加了大孔的形成几率,反过来会在铜阻挡层等比例微缩时损害台阶覆盖。最终,孔的连通还会为气体污染物、湿气、湿法清洗化学品、化学机械平坦化(CMP)浆料和用于阻挡层淀积的原子层淀积(ALD)前驱体提供扩散通道,因此需要对其加以控制,使微连通度小于2.0 nm。
3 应用导向
除这些普通的考虑外,低k材料的开发与应用的关系非常密切,往往要满足一些额外的需求。例如,在逻辑器件应用方面,理想的薄膜应该是孔隙率有限的ULK薄膜。然而,当前的开发中,为达到期望的k值,却不得不增加孔隙率。
存储器应用跟随着逻辑器件的路径,并有大约5年的延迟。在这种情况下,低k薄膜必须能经受住较高的电压操作,典型的电压约为15V,并且需要较高的机械性能和超过15GPa的弹性模量。特殊存储器的应用如闪存,根据所采用的工艺而定,可能需要高热稳定性和高场强下的经时绝缘击穿(TDDB)性能。
4 集成方案
铜和低k薄膜的集成变得更加复杂,因为集成工艺对铜电阻系数和有效k值都有影响,在此过程中,工艺参数统计波动的相对重要性持续上升。此外,定义正确方法的难度不可忽视,此方法将问题的基本方面与不完美的工艺分离,因此可能得到对 “互连”的真实评估。对合适的IC后道(BEOL)集成方案来说,选用每种特定的初始材料都需要考虑这些因素。
如果只是纯粹考虑铜大马士革集成中工艺引起的低k膜的损伤,我们知道随着k值的降低,薄膜对物理和化学损伤更加敏感。工艺导致的损伤被证明是集成结构中k值局部增加和/或可靠性降低的原因,这会消弱采用k电介材料的优势。工艺引发的低k膜损伤主要发生在等离子曝光过程中——包括刻蚀、去胶和CMP后等离子体清洗。
5 金属硬掩膜层
特定的材料性质和等离子体造成破坏的程度之间有什么样的关系,目前尚不清楚。在IMEC,主要是通过修改集成方案来减轻刻蚀和去胶等离子体操作导致的电介质退化,其中包括栅叠层选择,等离子体化学的选择,以及刻蚀与去胶的工艺顺序。对于孔隙率小于10%的低k薄膜,应用光刻胶掩膜(RM)集成方案;对于孔隙率比较高的材料,IMEC转向金属硬掩膜(MHM)集成方案(图1)。
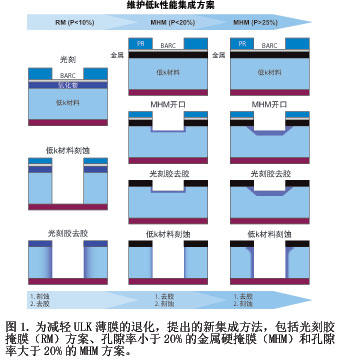
按此集成方法,在图形化过程中损伤会达到最小,接下来,CMP和/或铜还原后的CMP后等离子体清洗过程,以及残留的微粒清除过程也可能损伤介电薄膜。
在此前的研究中,研究人员证明了介电材料的机械性质在CMP后缺陷产生过程中扮演重要角色。他们的研究还表明,为减轻CMP导致的机械损伤,提高ULK 薄膜表面的机械性质会是一种可行的方法。因此在MHM淀积之前,沉积一层很薄的SiC层(约5nm)以增强薄膜的机械性能。其他小组用SiO2作为MHM 淀积之前的沉积材料,这一层通常被称为介电保护层(DPL)。MHM方案应用于高孔隙率和中孔隙率的低k薄膜时,其k值(keff)与体材料k值(刚完成沉积)的差异分别减小至0.0和0.2。(集成方案的品质因数是使△k = keff/k尽可能的小。)
将MHM集成方案移植到高孔隙率材料并不容易。金属硬掩膜下的损伤可能会扩展,导致keff的增加和后续湿法清洗中的线条扭曲。这种现象表明,精心选择的刻蚀、去胶和涉及到等离子体参数和工艺顺序的湿法清洗化学品,是决定最优化解决方案的关键。
提高窄线条的图形化性能,包括损伤和线条轮廓控制。接下来的部分将要介绍与低k薄膜有关的等离子体、湿法清洗和CMP工艺的进展。
- LCD TV整体电源解决方案-“GreenEngine?”技术(02-23)
- 在消费电子应用中考虑使用OTP存储器(04-13)
- 晶体元件在电子器件中不可缺(05-12)
- 用于移动电子设备的电路保护方案(11-08)
- 耳机设计:品质VS效率(01-07)
- SMARTCAR软件平台实现汽车电子系统软件的整体设计(03-30)
