低k集成的曙光
时间:10-10
来源:互联网
点击:
6 等离子体损伤
在大马士革集成中,避免线条轮廓扭曲、各向异性刻蚀现象、k值降低、成品率损失和低可靠性都是窄结构刻蚀的最大挑战。正如前文提到的,这些问题大部分起源于低k材料的刻蚀和去胶等离子体过程,并在BEOL工艺流程中被放大。目前正在考虑多种手段来克服这个问题。
一种使用金属或有机材料作为牺牲硬掩膜层的方法正在开发中,可以替代传统的SiO2和SiC无机硬掩膜层。与多孔SiOCH相比,金属和有机材料如 TiN、TaN和富碳层具有完全不同的化学性质,因此在选择性和各向异性刻蚀方面,比传统硬掩膜有更好的性能。但此方案不能完全阻止图形化过程中等离子体损伤的发生,所以需要更加根本地理解损伤机制。
7 低k沉积和光刻胶灰化
实际上,在铜/低k集成中的去胶工艺可以划分为两类主要方法。第一种是基于氧化和还原等离子体化学物质的低温、低压、各向异性光刻胶去胶。等离子体中的活性物质可以完成低温下去胶。然而,活性物质会流动渗透到多孔的含碳低k薄膜,导致碳损耗和后来的亲水化。
第二种去胶方法是在270-320℃的高衬底温度下,利用还原性的化学物质,通过等离子体流完成各向同性去胶。对于这种方法,我们在先进低k材料上研究了He/H2等离子体在各种衬底温度时的效果(图2和3)。低k薄膜通过基于致孔剂的PECVD方法沉积,热辅助紫外修复去除了致孔剂,产生出了孔隙。
8 低k刻蚀和湿法清洗
基于MHM图形化的实质是在刻蚀低k介电材料之前,将光刻胶去胶与等离子体刻蚀和灰化分离开。在光刻胶掩膜方案中,低k介质首先被刻蚀然后进行光刻胶去胶,必须严格遵循这个次序。相反,在MHM方案中,预期的图案被转移到MHM上,然后在刻蚀低k介质之前就可以去除光刻胶,或者先刻蚀低k材料然后去除光刻胶。在后一方案中,两个工艺步骤是独立的。光刻步骤的参数与介电材料无关。
必须对这些高分子层加以注意,将其完全清除才能阻止电良率的降低,尺寸低于100nm的情况尤其如此。图5展示了线条尺寸从150nm降低到90nm时,成品率损失的情况。这种现象能否得到增强,主要取决于低k介电材料的化学性质。对于一个k值约为 2.5、基于致孔剂、采用PECVD生长的ULK薄膜来说,这个问题可以通过刻蚀后的清洗步骤加以解决。由于低k介质的等比例微缩,需要考虑更高效的湿法清洗化学品。
9 化学机械平坦化导致的损伤
为研究CMP引发的损伤,需要开发出可靠的测量方法,首先是找到合适的测试工具。理想状态下,测试工具必须同时考虑CMP耗材、阻挡层和铜以及介电薄膜。一种途径是通过部分图形化方法产生类似国际象棋棋盘的结构,在晶圆的中心和边缘区域留下大片开阔区域。这种结构允许在同一晶圆上表征无图形的空白薄膜和有图形的集成结构。
直接CMP(无硬掩膜保护)之后,对于去除残留的有机物和吸附在ULK材料表面的水,退火方法被证明是十分有效的。然而,因为抛光表面的亲水性仍没有改变,它不能阻止水分吸附引起的k值增加。因此,为恢复疏水性和稳定表面,含有氯
硅烷反应基(-SiMenCl3-n)或者疏水甲基官能团的有机分子被以液相、气相或致密二氧化碳相的形式引入到损伤的ULK材料中。
这些有机处理对于恢复CMP处理后的ULK材料表面的疏水性都十分有效。然而,它们中只有一种能够维持低k值(与体ULK材料的k值相比),并且能够保持长时间稳定而不导致孔隙率的重大变化。
值得指出的是,这些修复溶液只能用于CMP导致的损伤。推荐的特别解决方案是由紫外修复方法提高ULK材料的性质、在ULK介质/金属界面嵌入“硬”保护层和仔细选择金属层组成。
尤其特别的是,如果用TaN作为铜阻挡层和/或MHM层,则推荐使用高机械强度的介电保护层以阻止CMP引发的损伤。通常,介电保护层由k值大约为 3.1-3.5、杨氏模量约为23GPa的致密SiCO:H薄膜或者PECVD 生长的SiO2薄膜组成。PECVD生长的中孔隙率ULK薄膜已经证明了TaN MHM和DPL联合使用的优点。DPL对渗漏和击穿性能具有正面影响,在热循环中没有观察到漏电流发生重大变化。这可归因于CMP抛光过程中湿气在ULK 材料里的吸附和解吸附,它是CMP抛光过程中刮擦和亲水化的结果。该结果表明DPL保护ULK薄膜免受CMP引发的损伤。
在存在和不存在DPL的情况下分别进行TDDB测量。存在DPL时,测试表明使用寿命可达10多年。而无DPL时候,经很短的时间便失效了。
在大马士革集成中,避免线条轮廓扭曲、各向异性刻蚀现象、k值降低、成品率损失和低可靠性都是窄结构刻蚀的最大挑战。正如前文提到的,这些问题大部分起源于低k材料的刻蚀和去胶等离子体过程,并在BEOL工艺流程中被放大。目前正在考虑多种手段来克服这个问题。
一种使用金属或有机材料作为牺牲硬掩膜层的方法正在开发中,可以替代传统的SiO2和SiC无机硬掩膜层。与多孔SiOCH相比,金属和有机材料如 TiN、TaN和富碳层具有完全不同的化学性质,因此在选择性和各向异性刻蚀方面,比传统硬掩膜有更好的性能。但此方案不能完全阻止图形化过程中等离子体损伤的发生,所以需要更加根本地理解损伤机制。
7 低k沉积和光刻胶灰化
实际上,在铜/低k集成中的去胶工艺可以划分为两类主要方法。第一种是基于氧化和还原等离子体化学物质的低温、低压、各向异性光刻胶去胶。等离子体中的活性物质可以完成低温下去胶。然而,活性物质会流动渗透到多孔的含碳低k薄膜,导致碳损耗和后来的亲水化。
第二种去胶方法是在270-320℃的高衬底温度下,利用还原性的化学物质,通过等离子体流完成各向同性去胶。对于这种方法,我们在先进低k材料上研究了He/H2等离子体在各种衬底温度时的效果(图2和3)。低k薄膜通过基于致孔剂的PECVD方法沉积,热辅助紫外修复去除了致孔剂,产生出了孔隙。

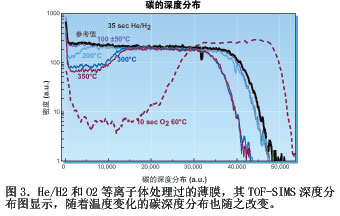
低k薄膜仍然是疏水性的,因此He/H2等离子体灰化处理并没有造成任何损害。结果表明,所研究的薄膜没有亲水化转变。此外,He/H2等离子去胶过度可能会提高孔隙率,而改性层不会发生亲水化转变,因此会进一步降低材料的k值。孔隙率的增加与剩余致孔剂的去除有关,并且没有初始材料中致孔剂是否完全去除的标志。然而,因为孔隙率增加能导致薄膜k值的降低,同时机械强度的损失相对较少,因此这种改性非但没有害处,反而是有益的。
8 低k刻蚀和湿法清洗
基于MHM图形化的实质是在刻蚀低k介电材料之前,将光刻胶去胶与等离子体刻蚀和灰化分离开。在光刻胶掩膜方案中,低k介质首先被刻蚀然后进行光刻胶去胶,必须严格遵循这个次序。相反,在MHM方案中,预期的图案被转移到MHM上,然后在刻蚀低k介质之前就可以去除光刻胶,或者先刻蚀低k材料然后去除光刻胶。在后一方案中,两个工艺步骤是独立的。光刻步骤的参数与介电材料无关。
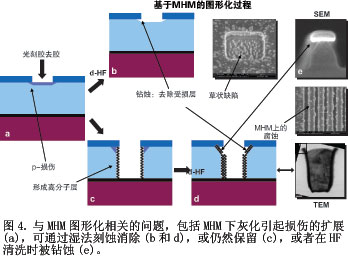
这种方法限制了薄膜暴露在等离子体中的次数,同时低k薄膜在去胶过程中被损坏的部分,也在刻蚀工艺中被去除了。然而,随着孔隙率的增加,灰化引起的损伤在MHM下逐渐扩大,而无法被刻蚀去除(图4a)。损伤部分在刻蚀后仍会保留下来(图4c),或是在湿法清洗过程中被去除(图4b和 4d),这取决于所使用的化学品。例如,在使用HF清洗时,钻蚀的出现(图4f)会影响线条形貌和阻挡层台阶覆盖。损伤性较低的刻蚀化学品可能会在沟槽的侧壁和MHM上留下聚合物层。
必须对这些高分子层加以注意,将其完全清除才能阻止电良率的降低,尺寸低于100nm的情况尤其如此。图5展示了线条尺寸从150nm降低到90nm时,成品率损失的情况。这种现象能否得到增强,主要取决于低k介电材料的化学性质。对于一个k值约为 2.5、基于致孔剂、采用PECVD生长的ULK薄膜来说,这个问题可以通过刻蚀后的清洗步骤加以解决。由于低k介质的等比例微缩,需要考虑更高效的湿法清洗化学品。
9 化学机械平坦化导致的损伤
为研究CMP引发的损伤,需要开发出可靠的测量方法,首先是找到合适的测试工具。理想状态下,测试工具必须同时考虑CMP耗材、阻挡层和铜以及介电薄膜。一种途径是通过部分图形化方法产生类似国际象棋棋盘的结构,在晶圆的中心和边缘区域留下大片开阔区域。这种结构允许在同一晶圆上表征无图形的空白薄膜和有图形的集成结构。
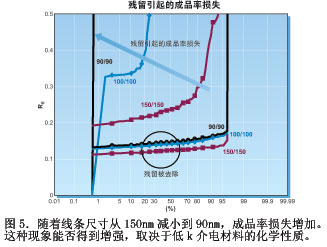
与低k材料表面相接触的金属层,可以是铜阻挡层或者MHM,这将影响到CMP后缺陷的形成和随后的亲水化过程。然而,这种损害的机制是可逆的。有些方法可以修复经过标准CMP和CMP后清洗工艺的低k材料。
直接CMP(无硬掩膜保护)之后,对于去除残留的有机物和吸附在ULK材料表面的水,退火方法被证明是十分有效的。然而,因为抛光表面的亲水性仍没有改变,它不能阻止水分吸附引起的k值增加。因此,为恢复疏水性和稳定表面,含有氯
硅烷反应基(-SiMenCl3-n)或者疏水甲基官能团的有机分子被以液相、气相或致密二氧化碳相的形式引入到损伤的ULK材料中。
这些有机处理对于恢复CMP处理后的ULK材料表面的疏水性都十分有效。然而,它们中只有一种能够维持低k值(与体ULK材料的k值相比),并且能够保持长时间稳定而不导致孔隙率的重大变化。
值得指出的是,这些修复溶液只能用于CMP导致的损伤。推荐的特别解决方案是由紫外修复方法提高ULK材料的性质、在ULK介质/金属界面嵌入“硬”保护层和仔细选择金属层组成。
尤其特别的是,如果用TaN作为铜阻挡层和/或MHM层,则推荐使用高机械强度的介电保护层以阻止CMP引发的损伤。通常,介电保护层由k值大约为 3.1-3.5、杨氏模量约为23GPa的致密SiCO:H薄膜或者PECVD 生长的SiO2薄膜组成。PECVD生长的中孔隙率ULK薄膜已经证明了TaN MHM和DPL联合使用的优点。DPL对渗漏和击穿性能具有正面影响,在热循环中没有观察到漏电流发生重大变化。这可归因于CMP抛光过程中湿气在ULK 材料里的吸附和解吸附,它是CMP抛光过程中刮擦和亲水化的结果。该结果表明DPL保护ULK薄膜免受CMP引发的损伤。
在存在和不存在DPL的情况下分别进行TDDB测量。存在DPL时,测试表明使用寿命可达10多年。而无DPL时候,经很短的时间便失效了。
- LCD TV整体电源解决方案-“GreenEngine?”技术(02-23)
- 在消费电子应用中考虑使用OTP存储器(04-13)
- 晶体元件在电子器件中不可缺(05-12)
- 用于移动电子设备的电路保护方案(11-08)
- 耳机设计:品质VS效率(01-07)
- SMARTCAR软件平台实现汽车电子系统软件的整体设计(03-30)
