什么是IGBT?如何使用此模块实现“双面水冷”,IGNT未来的发展趋势又是如何?
。
超结技术(super juncTIon)打破了传统硅器件的导通压降与耐压的极限关系(Ron∝VB2.5),可大大降低器件功耗,已成功应用在MOSFET上。将该技术应用在IGBT上,则可以进一步降低功耗,目前已受到广泛的关注。超结IGBT的主要难点是工艺实现,为了降低工艺难度,各种"半超结"结构被提出,实现性能与工艺的折中。
与此同时,IGBT的工艺水平也在不断提升,许多先进工艺技术,如离子注入、精细光刻等被应用到IGBT制造上。IGBT芯片制造过程中的最小特征尺寸已由5um,到3um, 到1um,甚至达到亚微米的水平。采用精细制造工艺可以大幅提高功率密度,同时可以降低结深,减小高温扩散工艺,从而使采用12英寸甚至更大尺寸的硅片来制造IGBT成为可能。随着薄片与超薄片加工工艺的发展,英飞凌在8英寸硅片上制造了厚度只有40um的芯片样品,不久的未来有望实现产品化应用。
此外,新材料如宽禁带半导体材料技术的发展,可以实现更低功耗、更大功率容量、更高工作温度的器件,其中SiC成为目前的大功率半导体的主要研究方向,并在单极器件上实现商品化,在IGBT等双极器件的研究上也不断取得进展。目前IGBT主要受制造工艺及衬底材料的缺陷限制,例如沟道迁移率及可靠性、电流增益较小及高掺杂P型衬底生长等问题,未来随着材料外延技术的发展,SiC IGBT将会实现突破。
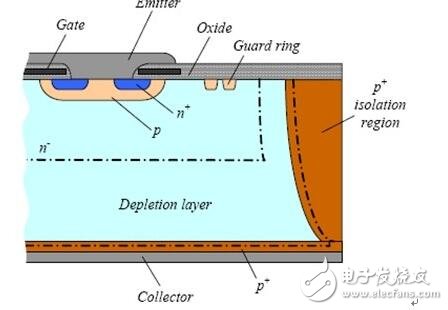
IGBT模块技术发展
随着IGBT芯片技术的不断发展,芯片的最高工作结温与功率密度不断提高, IGBT模块技术也要与之相适应。未来IGBT模块技术还将围绕芯片背面焊接固定与正面电极互连两方面不断改进,有望将无焊接、无引线键合及无衬板/基板等先进封装理念及技术结合起来,将芯片的上下表面均通过烧结或压接来实现固定及电极互连,同时在模块内部集成更多其他功能元件,如温度传感器、电流传感器及驱动电路等,不断提高IGBT模块的功率密度、集成度及智能度。
小结
本文从IGBT体结构、背面集电极区结构与正面MOS结构三方面分析了IGBT芯片的技术现状,目前IGBT芯片普遍采用平面栅或者沟槽栅结构,并运用软穿通体结构与透明集电极区结构技术,以及各种增强型技术,以提高综合性能和长期可靠性。高压IGBT模块技术还是以标准的焊接式封装为主,中低压IGBT模块产品则出现了很多新技术,如烧结取代焊接,压力接触取代引线键合,无衬板/基板封装等。未来IGBT将继续朝着集成化、智能化、小型化的方向发展。
- 用IGBT代替MOSFET的可行性分析(11-27)
- 以创新的IGBT技术、合理的器件选型和有效的系统手段优化变频器设计(01-09)
- 智能功率IGBT和MOSFET让汽车更加舒适环保(01-09)
- 单电源供电的IGBT驱动电路在铁路辅助电源系统中的应用(01-16)
- 面向汽车应用的IGBT功率模块浅谈(05-13)
- 使用栅极电阻控制IGBT的开关(04-13)
