40种常用的芯片封装技术
21、H-(with heat sink)
表示带散热器的标记。例如,HSOP 表示带散热器的 SOP。
22、Pin Grid Array(Surface Mount Type)
表面贴装型 PGA。通常 PGA 为插装型封装,引脚长约3.4mm。表面贴装型 PGA 在封装的 底面有陈列状的引脚,其长度从1.5mm 到2.0mm。贴装采用与印刷基板碰焊的方法,因而也称 为碰焊 PGA。因为引脚中心距只有1.27mm,比插装型 PGA 小一半,所以封装本体可制作得不 怎么大,而引脚数比插装型多(250~528),是大规模逻辑 LSI用的封装。封装的基材有多层陶瓷基板和玻璃环氧树脂印刷基数。以多层陶瓷基材制作封装已经实用化。

PGA 封装 威刚迷你 DDR333本内存
23、JLCC 封装(J-leaded chip carrier)
J 形引脚芯片载体。指带窗口 CLCC 和带窗口的陶瓷 QFJ 的别称(见 CLCC 和 QFJ)。部分半导体厂家 采用的名称。
24、LCC 封装(Leadless chip carrier)
无引脚芯片载体。指陶瓷基板的四个侧面只有电极接触而无引脚的表面贴装型封装。是高速和高频 IC 用 封装,也称为陶瓷 QFN 或QFN-C(见 QFN)。
25、LGA 封装(land grid array)
触点陈列封装。即在底面制作有阵列状态坦电极触点的封装。装配时插入插座即可。现已实用的有227 触 点(1.27mm 中心距)和447 触点(2.54mm 中心距)的陶瓷 LGA,应用于高速逻辑 LSI 电路。
LGA 与 QFP 相比,能够以比较小的封装容纳更多的输入输出引脚。另外,由于引线的阻抗小,对于高速 LSI 是很适用的。但由于插座制作复杂,成本高,现在基本上不怎么使用。预计今后对其需求会有所增加。

AMD 的2.66GHz 双核心的 Opteron F 的 Santa Rosa 平台 26、LOC 封装(lead onchip)
26、芯片上引线封装
LSI 封装技术之一,引线框架的前端处于芯片上方的一种结构,芯片的中心附近制作 有凸焊点,用引线缝合进行电气连接。与原来把引线框架布置在芯片侧面附近的结构相比,在相同大小的封装中容纳的芯片达1mm 左右宽度。

日立金属推出2.9mm 见方3轴加速度传感器
27、LQFP 封装(low profile quadflat package)
薄型 QFP。指封装本体厚度为1.4mm 的 QFP,是日本电子机械工业会根据制定的新 QFP外形规格所用的名称。
28、L-QUAD封装
陶瓷 QFP 之一。封装基板用氮化铝,基导热率比氧化铝高7~8 倍,具有较好的散热性。 封装的框架用氧化铝,芯片用灌封法密封,从而抑制了成本。是为逻辑 LSI 开发的一种封装,在自然空冷条件下可容许 W3的功率。现已开发出了208 引脚(0.5mm 中心距)和160 引脚(0.65mm 中心距)的 LSI 逻辑用封装,并于1993 年10月开始投入批量生产。
29、MCM封装
多芯片组件。将多块半导体裸芯片组装在一块布线基板上的一种封装。

根据基板材料可分为MCM-L,MCM-C 和MCM-D 三大类。
MCM-L 是使用通常的玻璃环氧树脂多层印刷基板的组件。布线密度不怎么高,成本较低。
MCM-C 是用厚膜技术形成多层布线,以陶瓷(氧化铝或玻璃陶瓷)作为基板的组件,与使用多层陶瓷基板的厚膜混合IC 类似。两者无明显差别。布线密度高于MCM-L。
MCM-D 是用薄膜技术形成多层布线,以陶瓷(氧化铝或氮化铝)或Si、Al 作为基板的组件。布线密谋在三种组件中是最高的,但成本也高。
30、MFP 封装( mini flatpackage)
小形扁平封装。塑料SOP 或 SSOP 的别称(见 SOP 和 SSOP)。部分半导体厂家采用的名称。

31、MQFP 封装 (metric quad flatpackage)
按照 JEDEC(美国联合电子设备委员会)标准对 QFP 进行的一种分类。指引脚中心距为0.65mm、本体厚度 为3.8mm~2.0mm的标准 QFP(见 QFP)。
32、MQUAD 封装 (metal quad)
美国 Olin 公司开发的一种 QFP 封装。基板与封盖均采用铝材,用粘合剂密封。在自然空冷条件下可 容许2.5W~2.8W 的功率。日本新光电气工业公司于1993 年获得特许开始生产。
33、MSP 封装 (mini squarepackage)
QFI 的别称(见 QFI),在开发初期多称为 MSP。QFI是日本电子机械工业会规定的名称。
34、OPMAC 封装 (over molded padarray carrier)
模压树脂密封凸点陈列载体。美国 Motorola 公司对模压树脂密封 BGA 采用的名称(见 BGA)。
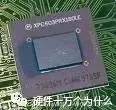
35、P-(plastic) 封装
表示塑料封装的记号。如PDIP 表示塑料 DIP。

36、PAC 封装 (pad arraycarrier)
凸点陈列载体,BGA 的别称(见 BGA)。

37、PCLP(printed circuit board leadless package)
印刷电路板无引线
芯片封装 相关文章:
- 一文告诉你最全的芯片封装技术(06-28)
