世界上只有十家公司能生产芯片组?40种封装方式都是那些?如何做好一块芯片?
芯片是怎样制造的:
芯片制作完整过程包括 芯片设计、晶片制作、封装制作、成本测试等几个环节,其中晶片片制作过程尤为的复杂。
首先是芯片设计,根据设计的需求,生成的"图样"
1, 芯片的原料晶圆
晶圆的成分是硅,硅是由石英沙所精练出来的,晶圆便是硅元素加以纯化(99.999%),接着是将些纯硅制成硅晶棒,成为制造集成电路的石英半导体的材料,将其切片就是芯片制作具体需要的晶圆。晶圆越薄,成产的成本越低,但对工艺就要求的越高。
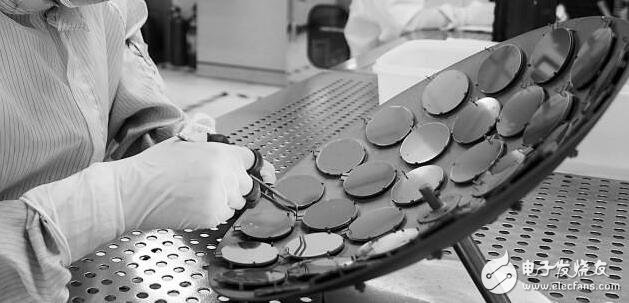
2,晶圆涂膜
晶圆涂膜能抵抗氧化以及耐温能力,其材料为光阻的一种。

3,晶圆光刻显影、蚀刻
该过程使用了对紫外光敏感的化学物质,即遇紫外光则变软。通过控制遮光物的位置可以得到芯片的外形。在硅晶片涂上光致抗蚀剂,使得其遇紫外光就会溶解。这是可以用上第一份遮光物,使得紫外光直射的部分被溶解,这溶解部分接着可用溶剂将其冲走。这样剩下的部分就与遮光物的形状一样了,而这效果正是我们所要的。这样就得到我们所需要的二氧化硅层。

4、搀加杂质
将晶圆中植入离子,生成相应的P、N类半导体。
具体工艺是是从硅片上暴露的区域开始,放入化学离子混合液中。这一工艺将改变搀杂区的导电方式,使每个晶体管可以通、断、或携带数据。简单的芯片可以只用一层,但复杂的芯片通常有很多层,这时候将这一流程不断的重复,不同层可通过开启窗口联接起来。这一点类似所层PCB板的制作制作原理。 更为复杂的芯片可能需要多个二氧化硅层,这时候通过重复光刻以及上面流程来实现,形成一个立体的结构。
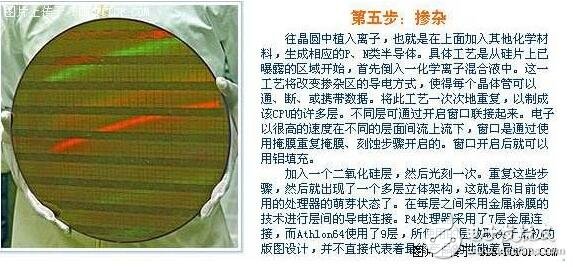
5、晶圆测试
经过上面的几道工艺之后,晶圆上就形成了一个个格状的晶粒。通过针测的方式对每个晶粒进行电气特性检测。 一般每个芯片的拥有的晶粒数量是庞大的,组织一次针测试模式是非常复杂的过程,这要求了在生产的时候尽量是同等芯片规格构造的型号的大批量的生产。数量越大相对成本就会越低,这也是为什么主流芯片器件造价低的一个因素。
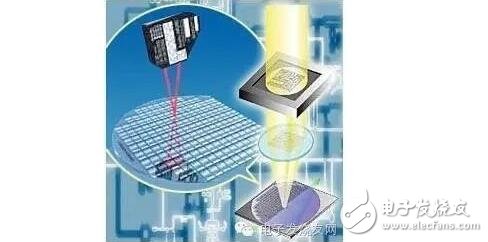
6、封装
将制造完成晶圆固定,绑定引脚,按照需求去制作成各种不同的封装形式,这就是同种芯片内核可以有不同的封装形式的原因。比如:DIP、QFP、PLCC、QFN 等等。这里主要是由用户的应用习惯、应用环境、市场形式等外围因素来决定的。

7、测试、包装
经过上述工艺流程以后,芯片制作就已经全部完成了,这一步骤是将芯片进行测试、剔除不良品,以及包装。
芯片的封装类型有哪些?
1、BGA 封装 (ball grid array)
球形触点陈列,表面贴装型封装之一。在印刷基板的背面按陈列方式制作出球形凸点用 以 代替引脚,在印 刷基板的正面装配 LSI 芯片,然后用模压树脂或灌封方法进行密封。也 称为凸 点陈列载体(PAC)。引脚可超过200,是多引脚 LSI 用的一种封装。 封装本体也可做得比 QFP(四侧引脚扁平封装)小。例如,引脚中心距为1.5mm 的360 引脚 BGA 仅为31mm 见方;而引脚中心距为0.5mm 的304 引脚 QFP 为40mm 见方。而且 BGA 不 用担 心 QFP 那样的引脚变形问题。 该封装是美国 Motorola 公司开发的,首先在便携式电话等设备中被采用,今后在 美国有 可 能在个人计算机中普及。最初,BGA 的引脚(凸点)中心距为 1.5mm,引脚数为225。现在 也有 一些 LSI 厂家正在开发500 引脚的 BGA。 BGA 的问题是回流焊后的外观检查。现在尚不清楚是否有效的外观检查方 法。有的认为 , 由于焊接的中心距较大,连接可以看作是稳定的,只能通过功能检查来处理。 美国 Motorola 公司把用模压树脂密封的封装称为 OMPAC,而把灌封方法密封的封装称为 GPAC(见 OMPAC 和 GPAC)。

2、BQFP 封装 (quad flat package with bumper)
带缓冲垫的四侧引脚扁平封装。QFP 封装之一,在封装本体的四个角设置突起(缓冲垫) 以 防止在运送过程 中引脚发生弯曲变形。美国半导体厂家主要在微处理器和 ASIC 等电路中 采用 此封装。引脚中心距0.635mm, 引脚数从84 到196 左右(见 QFP)。

3、碰焊 PGA 封装 (butt joint pin grid array)
表面贴装型 PGA 的别称(见表面贴装型 PGA)。

4、C-(ceramic) 封装
表示陶瓷封装的记号。例如,CDIP 表示的是陶瓷 DIP。是在实际中经常使用的记号。

5、Cerdip 封装
用玻璃密封的陶瓷双列直插式封装,用于 ECL RAM,DSP(数字信号处理器)等电路。带有 玻璃窗口的Cerdip
用于紫外线擦除型 EPROM 以及内部带有 EP
- 如何查看电脑芯片组,怎么看电脑芯片组(07-09)
- 电脑芯片组高低性能怎么区分?(07-09)
- 评测:采用AMD APU平台的联想启天M5800——均衡+全能(02-17)
- AMD/NVIDIA功耗指标TDP/TBP等背后的意义(07-25)
- AMD将推Win 8低电压处理器 与英特尔竞争(04-24)
- 如何看AMD授权x86专利给中国合资企业(03-27)
