实时功率GaN波形监视
简介
功率氮化镓器件是电源设计人员工具箱内令人激动的新成员。特别是对于那些想要深入研究GaN的较高开关频率如何能够导致更高频率和更高功率密度的开发人员更是如此。RF GaN是一项已大批量生产的经验证技术,由于其相对于硅材料所具有的优势,这项技术用于蜂窝基站和数款军用/航空航天系统中的功率放大器。在这篇文章中,我们将比较GaN FET与硅FET二者的退化机制,并讨论波形监视的必要性。
使用寿命预测指标
功率GaN落后于RF GaN的主要原因在于需要花时间执行数个供货商所使用的成本缩减策略。最知名的就是改用6英寸的硅基板,以及更低成本的塑料封装。对于电源设计人员来说,理解GaN有可能带来的性能提升,以及某些会随时间影响到最终产品性能的退化机制很重要。
联合电子设备工程委员会 (JEDEC) 针对硅器件的认证标准经证明是产品使用寿命的很好预测指标,不过目前还没有针对GaN的同等标准。要使用全新的技术来减轻风险,比较谨慎的做法是看一看特定的用例,以及新技术在应用方面的环境限制,并且建立能够针对环境变化进行应力测试和监视的原型机。对于大量原型机的实时监视会提出一些有意思的挑战,特别是在GaN器件电压接近1000V,并且dv/dts大于200V/ns时更是如此。
一个经常用来确定功率FET是否能够满足目标应用要求的图表是安全工作区域 (SOA) 曲线。图1中显示了一个示例。
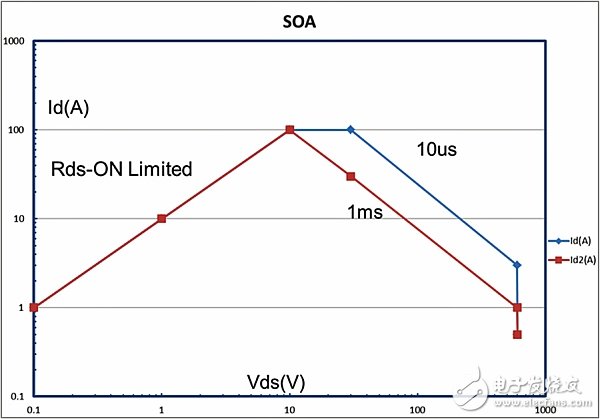
图1.GaN FET SOA曲线示例,此时Rds-On = 毫欧
硬开关设计
功率GaN FET被用在硬开关和数MHz的谐振设计中。上面展示的零电压 (ZVS) 或者零电流 (ZCS) 拓扑为数千瓦。SOA曲线的应力最大的区域是右上角的电压和电流最高的区域。在这个硬开关区域内运行一个功率GaN FET会导致由数个机制而造成的应力增加。最容易理解的就是热应力。例如,在使用一个电感开关测试电路时,有可能使器件从关闭时的电流几乎为零、汲取电压为几百伏,切换到接通时的电流几乎瞬时达到10A。
器件上的电压乘以流经的电流可以获得瞬时功率耗散,对于这个示例来说,在转换中期可以达到500W以上。对于尺寸为5mm x 2mm的典型功率GaN器件,这个值可以达到每mm2 50W。所以用户也就无需对SOA曲线显示的这个区域只支持短脉冲这一点而感到惊讶了。由于器件的热限值和封装的原因,SOA曲线的右上部被看成是一个脉宽的函数。由于曲线中所见的热时间常数,更短的脉冲会导致更少的散热。增强型封装技术可被用来将结至环境的热阻从大约15°C/W减小到1.2°C/W。由于减少了器件散热,这一方法可以扩大SOA。
SOA曲线
德州仪器 (TI) 有一个系列的标准占板面积的功率MOSFET、DualCool™ 和NexFETs™。这些MOSFET通过它们封装顶部和底部散热,并且能够提供比传统占板面积封装高50%的电流。这使得设计人员能够灵活地使用更高电流,而又无需增加终端设备尺寸。与硅FET相比,GaN FET的一个巨大优势就是可以实现的极短开关时间。此外,减少的电容值和可以忽略不计的Qrr使得开关损耗低很多。在器件开关时,电压乘以电流所得值的整数部分是器件必须消耗的功率。更低的损耗意味着更低的器件温度和更大的SOA。
SOA曲线所圈出的另外一个重要区域受到Rds-On的限制。在这个区域内,器件上的电压就是流经器件的电流乘以导通电阻。在图1所示的SOA曲线示例中,Rds-On为100毫欧。硅MOSFET的温度取决于它们的Rds-On,这一点众所周知。在器件温度从25ºC升高至大约100ºC时,它们的Rds-On几乎会加倍。
动态Rds-On
GaN FET具有一个复杂的Rds-On,它是温度,以及电压和时间的函数。GaN FET的Rds-On对电压和时间的函数依赖性被称为动态Rds-On。为了预测一个GaN器件针对目标使用的运行方式,很有必要监视这些动态Rds- On所带来的影响。与SOA曲线的温度引入应力相类似,电感硬开关应力电路比较适合于监视Rds-On。这是因为很多潜在的器件退化是与高频开关和电场相关的。
图2是一个简单开关电路,这个电路中给出了一种在SOA右上象限内实现循环电流,并对器件施加应力的方法。
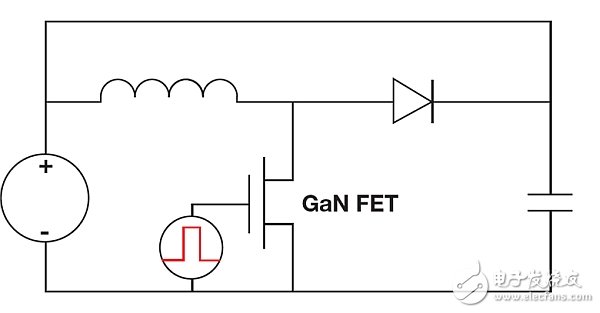
图2.电感硬开关测试电路
宽带隙
GaN是一种宽带隙材料,与硅材料的1.12eV的带隙相比,它的带隙达到3.4eV。这个宽带隙使得器件在被击穿前,能够支持比同样大小的硅器件高很多的电常某些器件设计人员常用来帮助确定器件可靠性的测试有高温反向偏置 (HTRB)、高温栅极偏置 (HTGB) 和经时电介质击穿 (TDDB)。这些都是静态测试,虽然在验证器件设计有效性方面是好方法,但是在高频开关动态效应占主
功率GaN 相关文章:
- LT3751如何使高压电容器充电变得简单(08-12)
- 三路输出LED驱动器可驱动共阳极LED串(08-17)
- 浪涌抑制器IC简化了危险环境中电子设备的本质安全势垒设计(08-19)
- 严酷的汽车环境要求高性能电源转换(08-17)
- 适用于工业能源采集的技术 (08-10)
- 单片式电池充电器简化太阳能供电设计(08-20)
