深度分析白光LED的散热技术
经成为散热组件的一部份。接着介绍有关散热的处理方式。
封装与散热基板的功能
散热设计必需考虑如何使LED芯片产生的热透过筐体释放到外部。图9是LED Lamp内部的热流与封装内侧理想热扩散模式。
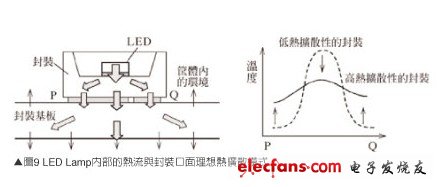
如图9右侧实线所示,高热扩散性封装的内侧(P~Q之间)温度分布非常平坦,热可以扩散至封装整体,而且还非常顺畅流入封装基板内,因此LED芯片正下方的温度大幅下降。
图10是利用热模拟分析确认该状态获得的结果,该图表示定常状态温度分布,与单位面积时的单位时间流动的热量,亦即热流束的分布状况。由图可知使用高热传导材料的场合,封装内部的温差会变小,此时并未发现热流集中在局部,封装内部的热扩散性因而大幅提高。

陶瓷是由铝或是氮化铝制成,若与目前常用的封装材料环氧树脂比较,铝质陶瓷的热传导率是环氧树脂的55倍,氮化铝陶瓷的热传导率是环氧树脂的400倍。此外金属板的热传导率大约是200W/mK,铝的热传导率大约是400W/mK左右,要求高热传导率的封装,大多使用金属作base。
LED芯片接合剂的功能
半导体芯片接合剂使用的材料有环氧系、玻璃、焊锡、金共晶合金等等。LED芯片用接合剂除了高热传导性之外,基于接合时降低热应力等观点,要求低温接合、低杨氏系数等特性,符合要求的在环氧系有"添加银的环氧树脂",共晶合金则有"Au -20% Sn"等等。
接合剂附着在芯片周围的面积几乎与LED芯片相同 ,而且无法期待水平方向的热扩散,只能期望垂直方向的热传导性。图11是LED芯片至封装背面的温度差热仿真分析的结果,如图所示封装使用氮化铝陶瓷基板,与接合部温度差,以及热传导性比添加银的环氧树脂还低的Au-Sn接合剂。
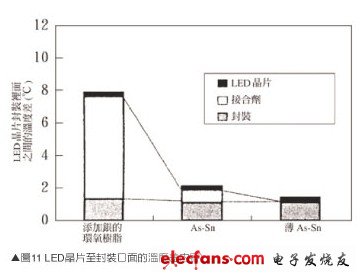
由于Au-Sn薄层化可以降低接合部的温度差,同时有效促进热的流动,因此业界普遍认为未来散热设计,势必要求接合剂必需具备高热传导性,与可以作薄层化接合等基本特性。
今后散热设计与封装构造
随着散热设计的进化,LED组件厂商的研究人员开始检讨LED Lamp至筐体的热传导,以及筐体至外部的热传导可行性;组件应用厂商与照明灯具厂商则应用实验与模拟分析进行对策研究。
有关热传导材料,封装材料正逐渐从树脂切换成金属与陶瓷材料。此外LED芯片接合部是阻碍散热的要因之一,因此上述薄形接合技术被视为今后检讨课题之一。
有关提高筐体至外部的热传导,目前大多利用冷却风扇与散热鳍片达成散热要求。不过基于噪音对策与窄空间化等考虑,照明灯具厂商大都不愿意使用热交换器,因此必需提高与外部接触面非常多的封装基板与筐体的散热性,具体方法例如利用远红外线在高热传导性铜层表面,形成可以促进热放射涂抹层的可挠曲散热膜片(film)。
根据测试结果证实可挠曲散热膜片的散热效果,比大小接近膜片的散热鳍片更高,因此研究人员检讨直接将可挠曲散热膜片黏贴在封装基板与筐体,或是将可以促进热放射涂抹层,直接设置在装基板与筐体表面,试图藉此提高散热效果。
有关封装结构,必需开发可以支持LED芯片磊晶(flip chip)接合的微细布线技术;有关封装材料,虽然氮化铝的高热传导化有相当进展,不过它与反射率有trade-off关系,一般认提高热传导性比氮化铝差的铝的反射特性,可以支持LED高输出化需要,未来可望成为封装材料之一。
- “封装热导”原理技术探析(09-22)
- 苹果离子风散热技术或有望取代传统机械风扇(10-07)
- 解决手机散热这个老大难问题,这个技术够牛(02-16)
- 浅谈大屏拼接灯具的散热技术(06-20)
- 鸿利光电推出新一代扁平结构白光产品(09-30)
- 浅析白光LED在室内照明中应用(05-03)
