GaN基微波半导体器件研究进展
1996 年,Jinwook Burm 等人[13] 采用OMPVE技术在(0001)蓝宝石衬底上制造出了性能非常好的MODFET 结构,包括空间层、隔离电荷提供层以及薄沟道,见图6。其在24V的漏源偏置电压下的截止频率f T 和最高振荡频率f max 分别可以达到21.4GHz和77.5GHz,充分显示出GaN MODFET 在微波大功率应用方面的强大优势。
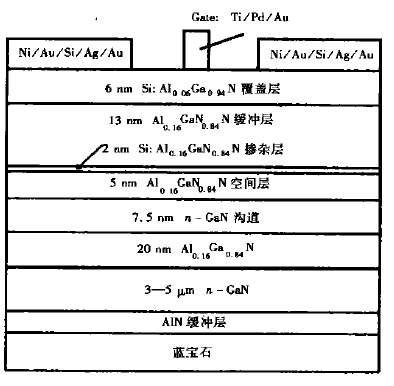
图6、MODFET 层结构
图7 给出了当频率在1 ~ 20GHz 间时,GaN MODFETs 与其他一些微波器件功率密度的比较。从图中可看出,GaN MODFETs 在频率为10 GHz 和18 GHz处的射频功率密度分别为6.8W/ mm 和3.3W/ mm,而SiC MESFET 的CW 和脉冲射频功率密度仅为10 ~ 3.3W/ mm,都比同一频率下的GaNMODFETs 所报道的最高值低。此外,从图中还可以看出,在频率大于10GHz的情况下,GaN MODFETs 比SiCMESFETs 在微波应用方面更具有优势,这主要归于调制掺杂以及随之增加的输运特性的原因。
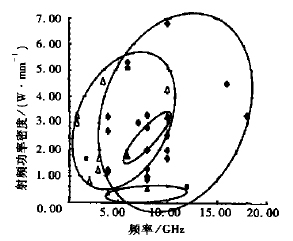
图7、GaN MODFETs 与其他RF 技术的功率密度的比较
图8 是GaN MODFETs 与其他微波器件输出功率的比较。在图7 与图8 中,●为Si 浅漏金属氧化物半导体场效应晶体管(连续波),◆为SiC 静电感应晶体管(脉冲波),△为SiC 金属半导体场效应晶体管(连续波),▲为SiC 金属半导体场效晶体管(脉冲波),◆为GaN 调制掺杂场效应晶体管(连续波),●为P-GaAs 高电子迁移率晶体管(连续波),GaAs 异质结结型场效应晶体管(连续波),■为GaAs 金属半导体场效应晶体管(连续波)。从图8 中可看出,GaN MODFETs 总的输出功率相对较低。低频情况下(< 1.0GHz),输出功率为100W到1 000W之间时,SiC SITs 和Si 基LDMOS 占有极大的优势。当频率为3.0GHz时,SiC MESFETs 在输入为连续波时射频输出功率超过6W,但GaN MODFET 最高输出功率在10.0GHz处仅为4.0W。之所以出现这种情况,主要是由于GaN MODFETs 微波功率技术目前还不够成熟。但总的来说,GaN MODFET 还是显示出其在8.2~ 12.4GHz的频率范围内具有极大的优势。相信随着GaN 微波功率技术的不断提高,会制造出微波性能越来越好的GaN MODFET 微波器件。
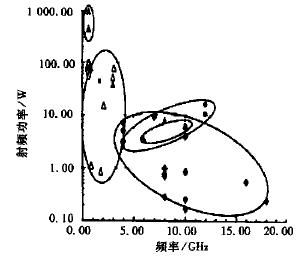
图8、GaN MODFETs 与其他RF 技术的输出功率的比较
2.3、金属绝缘物场效应晶体管
在某些应用中,人们需要获得非常低的栅泄漏电流,而采用绝缘体栅代替肖特基栅,并在HFET 结构中采用一个掺杂的GaN 层一个未掺杂的AlGaN 层就可以满足这一要求,即形成金属绝缘物场效应晶体管结构。Binari 等人[14] 成功地在GaN 上直接制造出了MISFETs,获得的跨导为16mS/ mm。之后,Q.Chen 等人[6] 则在AlGaN/ GaN 异质结上成功地制造出MISFETs。其具体的结构包括:生长在蓝宝石衬底上的半绝缘GaN 层,厚度为1μm;50 nm的n 型GaN 层和3 nm的Al0.2Ga0.8N 未掺杂空间层以及30 nm的掺杂Al0.2Ga0.8N 层。工艺过程中使用Ti/ Al 金属结构作为欧姆接触,SiO2 作为栅绝缘物。当电压在- 6V 和+ 6V 之间时,最大跨导为86mS/ mm,充分显示出了其高功率应用的优势,但截止频率f T 和最大振荡频率f max 仅为2.9 GHz和7.1GHz,这可能是由于栅和漏源间的重叠形成一个大的负反馈电容,因此减小了射频增益,限制了f T 和f max。
3、GaN 基微波器件关键工艺的研究进展
制造高性能GaN 微波器件不仅与材料质量有很大关系,而且也与器件制备工艺紧密相关。因此,了解当前GaN 微波器件的工艺研究进展是非常必要的。
3.1、欧姆接触
低的欧姆接触电阻是制作高性能微波器件的关键。相对较窄带隙的Si,GaAs 和InP 等材料而言,在GaN上制备低的欧姆接触电阻较为困难。这是因为GaN 有较宽的带隙,在金属和半导体界面接触处的接触势垒较高,从而导致大的欧姆接触电阻。为了降低欧姆接触电阻,目前采用淀积多层金属的方法在界面处形成低势垒的多元合金或高的掺杂浓度。
合金欧姆接触 这种方法主要是通过真空和电子束蒸发Al,Au 或Ti/Ag 而在GaN 上形成低的欧姆接触的。Wu 等人采用两步淀积Ti 薄膜及热退火工艺技术对较低掺杂浓度的GaN 获得的比接触电阻为5.0X10- 6~ 5.5X10- 6Ω·cm2,对较高掺杂浓度的GaN 获得的比接触电阻为3.0X10- 6~ 4.1X10- 6Ω·cm2。Fan 等人首先以Cl2 和BCl3 为刻蚀剂对在蓝宝石衬底上生长的GaN 进行反应离子刻蚀,形成适合于电阻测量的台阶结构。其后,在蒸发室中淀积Ti/ Al/Ni/ Au 形成多层欧姆接触薄膜。对掺杂浓度为2X1017Ω·cm- 3和4X1017Ω·cm- 3的n 型GaN,获得的比接触电阻分别为1.19X10- 7Ω·cm2和8.9X10- 8Ω·cm2,较为理想[17,18]。
非
