故障预测技术在半导体设计中应用
3 .2 热载流子(HC)的故障预测 目前,通过施加电应力加速MOS器件中热载流子效应的产生,并以器件的某些参数(例如阈值电压Vth、跨导gm等)变化量达到行业标注为失效判据,估算出器件在应力作用下的寿命值,再根据一定的模型推算出正常工作条件下的寿命值-既芯片的设计寿命。Ridgetop-Group 提出了用在芯片中附加热载流子单元方法来监测热载流子效应,实时监测芯片的健康状态和芯片的剩余使用寿命,使芯片的效能达到最大化。介绍一下HC单元的示意图6. 和应用图7. 图6 HC单元示意图 如图7.HC单元与主电路被放在一起,与主电路一样受相同的外界应力影响,这些外界应力决定着芯片的寿命。当主电路在测试方式下,这个单元将触发,进入到预定的、连续的应力和测试循环,最终给出电路真正的寿命。 能够预测主电路的使用寿命,给出预测报警点,但是它需要占用额外的芯片管脚。
热载流子容易在N沟道MOS管靠近漏极处在二氧化硅或硅处形成负电荷陷阱. 热载流子效应是MOS管的一个重要失效机理,是大家所不希望的. 热载流子容易导致MOS管的Vt增加和Id减小.示意图4和图5. 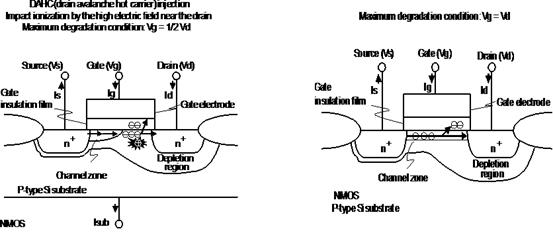


图7. HC单元应用图
TDDB效应的故障预测
TDDB效应是由小几何体, 多沟道,薄栅氧化层, NMOS 衬底注入引起的, 它容易造成噪声增加,功耗增加,MOS管器件电参数不稳定,如:阑值电压漂移、跨导下降和漏电流增加等,甚至可引起MOS管失效。Ridgetop-Group TDDB 故障预测单元是利用和主电路在一起的利用JTAG 技术的TDDB物理单元加HALT 测试方法来实现的。
NBTI效应的故障预测
NBTI效应主要130纳米及以下工艺中。当栅源的电压是负电压,PMOS 容易发生NBTI效应。在氧化硅和硅的界面处,负偏压和/或温度容易造成正阱,造成Vt 增加和Id的减少。造成电性的间歇性和失效, 导致芯片可靠性和寿命降低。Ridgetop-Group TDDB 故障预测单元是利用和主电路在一起的NBTI物理单元来实现的。
对于在半导体中的金属迁移和辐射等效应,它们都在影响半导体寿命,有同样类似的单元来对金属迁移和辐射效应等进行预测,只是它们针对不同的目的,不同的问题。这些单元与客户的主电路隔离开,互不干扰,但它们实现了芯片内部的自检测试(BIST),达到要检测的目的。对于这些效应的预测,请查阅Ridgetop Group 工作网站。
4 总结
故障预测技术是可以应用在半导体设计中的,随着最终用户的要求越来越高,也要求芯片性能越来越高,如果能够预测芯片的寿命,使系统维修和芯片的替换变得更容易、更简单。上述这些半导体效应是不能避免的,但是它们是可以预知的, 因此故障预测技术可以应用在半导体设计领域,将故障预测范围缩小到芯片级,避免重大恶性事故发生。
- 用LatticeXP FPGA 桥接吉比特媒体独立接口(01-18)
- 让LM1875声音更靓(02-07)
- 适合LIN总线控制车门区域应用的高级电源管理器件(02-01)
- 现代通信系统电源设计(02-13)
- 便携式应用处理器设计中的电源管理(03-02)
- 利用智能交流电控制增加家电系统的安全性(04-23)
