毫米波电路及天线的3D集成和封装:新的机遇和挑战
时间:10-21
来源:射频百花潭
点击:
当前进展
Leti 正在进行的研究旨在创建一个新一代毫米波中介层封装,相比其他竞争技术具有增强的电气和机械性能以及合理的成本和可制造性。新的模块,目前正在进行规划和预制分析,保持与第一个示范相同的整体厚度 ;然而,由于综合高阻抗表面(HIS)反射器设计,总面积减少了大约 33%(从 6.5 mm × 6.5 mm 到 5.3 mm × 5.3 mm)(见图 6a)12。如图 6b 所示,有两个用于提高天线性能的改进正被评估。第一个是在中介层顶部层压成型聚合物和处理金属寄生贴片来增强带宽。第二是采用外部介质透镜来提供中距离通信功能(约 10 米)。在这种情况下,在 60 GHz 的目标增益为15 dBi。所提镜头的设计基于半球形和抛物线几何结构,并采用 PA6 级加工塑料(εr= 4.3)。四个设计中的两个,直径为 6 毫米和 1 厘米的半球形透镜,已得到实验验证。首次测量使用了开放 WR15 波导馈电,增益在 57 至 66GHz 时为 12 至 16 dBi。根据系统级验证工作流程,这些镜头都集成了 60GHz QFN 收发器模块 13,结果显示提高了通信距离,发射透镜为 4 倍,发送和接收透镜为 7.5 倍。
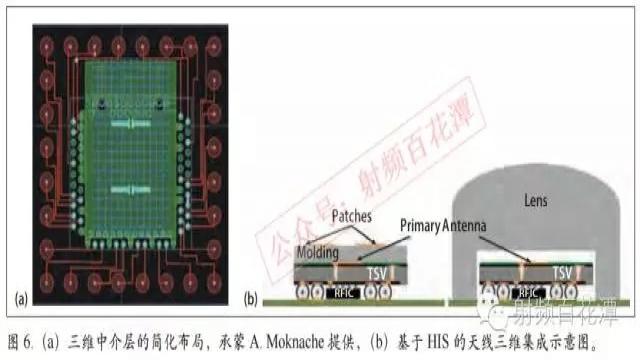
- PDH、SDH、微波通信及毫米波技术介绍(11-20)
- 60GHz毫米波通信技术及发展趋势(12-14)
- 毫米波光载无线系统的结构优化(09-04)
- 基于光纤无线融合的射频无源光网络(07-09)
- 光载毫米波无线电通信技术的现状与发展(09-16)
- 解读5G八大关键技术(07-02)
