毫米波电路及天线的3D集成和封装:新的机遇和挑战
直到70年代后期,尚未开发的毫米波(mmWave)(频率范围30至300GHz)被限制于特殊应用,比如光谱学和军事雷达。前端的复杂性和非标制造技术使得毫米波模块成本远远高于高容量市场和消费市场能接受的程度。
自80年代初以来,研发机构在毫米波技术领域已取得重大进展,并在半导体行业得以实现,为其广泛应用开辟了新的视野 :高速数据通信、汽车雷达、机载导弹跟踪系统、空间光谱检测和成像。
毫米波元件市场的全球收入 2013 年估计为 1.16 亿美元,到2018 年预计达到 11 亿美元,复合年度增长率(CAGR)约为 59%。虽然这可以被行业视为一个巨大的经济机会,新兴的应用正带来特殊的挑战,如电气性能、紧凑结构、集成可能性和系统可靠性等方面。
本文聚焦于短到中距离的通讯设备,说明与无线收发器的集成以及它们与其他元件共存相关的一些技术挑战。
无源器件的典型尺寸开始与标准电子封装兼容,毫米波的短波长正可视作将其集成的一个机会。对于某些应用,大型器件如波导、连接器、非面滤波器和大型天线阵列,向完全集成和小型化系统的进展仍然缓慢。对于短距离的 60 GHz 通信,便携式设备是未来十年主要的市场驱动力——因此需要完全集成、紧凑和高性能的收发器。对于天线,小型化过程受到辐射源面积与可达增益之间的基本关系所限 ;这往往被视为无线收发器完全集成的瓶颈。
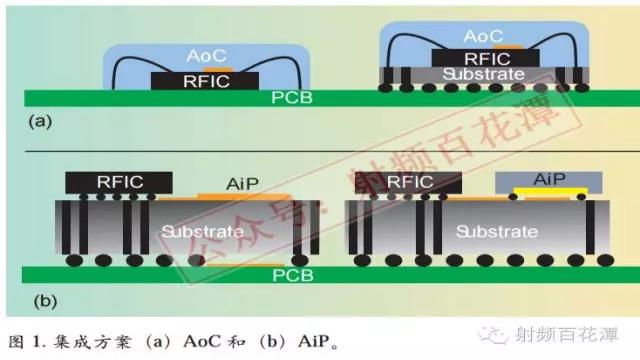
集成收发器与天线
片上天线(AoC)的方法包括将辐射元件直接集成到射频芯片栈的后端,无论它是采 用 CMOS、BiCMOS 还 是 III-V 族技术制造的(见图 1a)。该解决方案的主要优点在于,在一个大小仅为几平方毫米的单一模块上,没有任何射频互连和所有射频与基带功能的相互集成。然而,硅基的 AoC、基板的高介电常数(εr=11.7 至 11.9)和低电阻率(ρ ≈ 10Ω · cm)严重降低了匹配带宽和辐射效率。不过,AoC 的性能可以通过局部修改基板的性能得到提高。例如,可以通过在辐射元件下蚀刻气腔或采用一个悬浮的隔膜来完成。在这两种情况下空气层的存在会减少介电损耗和降低有效介电常数。其他创新的解决方案包括硅衬底电阻率的局部修改,采用离子注入法或上述芯片集成耦合辐射元件。

在封装天线(AiP)的集成方法中,天线是在一个单独基板上实现的,独立于 RFIC 芯片(参见图 1b)。该基板可以专门用于辐射元件及其馈送线,也可以起到包装收发器零件和异构集成的作用。出于这个原因,AiP设计在毫米波收发器的三维集成场景中发挥着关键作用,同时提供一个额外的自由度,用来选择低介电常数和/ 或高电阻率的衬底。此外,天线平台的允许面积可能比 AoC 的大。因此,集成天线性能的一个有效比较基准应该考虑所分配的面积,则我们可以定义一个新的品质因数归一化单位面积实现的增益(线性尺度)。图 2绘出了 60 GHz 集成天线的文献调查数据,表明 AiP 的增益高于 AoC 的两到四倍,这是由于使用低损耗衬底代替了 CMOS 级硅。
主流的毫米波封装
对于无线收发器集成的一个给定技术选择,取决于几个约束条件的权衡 :电气性能、热机械可靠性、体积紧凑性、可制造性和成本。传承于已有良好建树和成熟的 PCB 技术,当今的高密度互连(HDI)设计规则可实现小于 40µm 的布线与空隙以及直径不足 100µm 的微过孔,这是满足毫米波集成所要求的。此外,新一代的多层有机(MLO)封装采用薄厚薄膜配置的高质量电介质。这样的一个结果是,标准 FR-4 和再分配层压板逐步由低损耗介电材料,如 RO族和液晶聚合物(LCP),所取代。作为 一 个 例 子,STMicroelectronics 开发了 60 GHz 的 HDI 有机封装,采用的是一种基于 RO4003C 的对称层叠的技术。
在相同的情况下,大约 20 年前引入了陶瓷封装以满足关键系统的需求,得益于其化学稳定、机械可靠性和密封组件等性能。陶瓷加工可以制作各种过孔和型腔结构,并可装配外部电容和电感。标准多层陶瓷封装的垂直分辨率大约是 50µm。目前采用的两种主要的多层陶瓷工艺是低温共烧陶瓷(LTCC)和高温共烧陶瓷(HTCC),其各自的最
- PDH、SDH、微波通信及毫米波技术介绍(11-20)
- 60GHz毫米波通信技术及发展趋势(12-14)
- 毫米波光载无线系统的结构优化(09-04)
- 基于光纤无线融合的射频无源光网络(07-09)
- 光载毫米波无线电通信技术的现状与发展(09-16)
- 解读5G八大关键技术(07-02)
