埋嵌元件PCB的技术(一)
1 前言
埋嵌元件基板由于元器件的三维配置而使PCB或者模组小型化,缩短元件之间的连接路径,降低传输损失,它是可以实现便携式电子设备多功能化和高性能化的安装技术。多层板中埋嵌LSI或者无源元件方式的埋嵌元件基板从2003年开始采用,从2006年开始正式用作高功能便携电话或者用于表用的小型模组基板。这些基板分别采用了元件制造商和PCB制造商独自开发的特征构造和工艺。本文就参考日本电子电路工业协会(JPCA)的规格中埋嵌方式的埋嵌元件基板技术的分类,采用的元件和安装技术和评价解析等加以介绍。
2 埋嵌元件基板技术的分类
埋嵌元件基板大致分为埋嵌个别制造的元件的方式和在基板上形成直接元件的方式。本人只限于前者方式的技术。图1表示了埋嵌型的埋嵌元件基板按照嵌入元件的安装方式的分类。PCB上的元件安装方式大致有焊盘连接方式和导通孔连接方式两大类。

图2表示了焊盘连接方式和导通孔连接方式的代表性制造工艺。
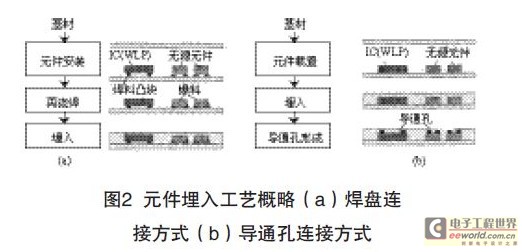
在焊盘连接方式中,首先在基板上形成的电极上安装嵌入的元件并进行电气连接。连接完成以后采用绝缘树脂同时填充和埋没元件和电极。连接时采用现有的表面安装技术。连接材料采用焊料或者导电胶。嵌入元件的安装:元件为裸芯片时选择裸芯片粘结(Die Bonding);元件为无源元件或者模塑封装(Mould Package)或者WLP(Wafer LevelChip Scale Package)时安装选择(Mounting):裸芯片的倒芯片连接(Flip Chip Bond)采用超声波接合、C4(Controlled Collapse Chip Connection控制熔化高度芯片连接)、ESC(Epoxy Encapsulated SolderConnection环氧树脂囊包焊接)、导电性树脂和各向异性导电树脂(ACF/ACP,Auisotropic ConducliveFilm /Anisoropic Conductive Paste)和非导电性树脂(NCF/NCP,Non Conductive Film / Non CondctivePaste)等安装技术。无源元件的连接采用焊料再流焊或者导电性树脂。焊盘连接方式中由于元件连接采用传统的表面安装技术而具有有效利用现有制造设备的优点。另外,由于实施了元件安装连接以后和埋嵌以前的检查,所以可以对安装过程中发生的不良品进行筛选或者修理和返工。
导通孔连接方式中,PCB和元件进行电气连接以前采用绝缘树脂埋嵌元件。元件埋置以后,覆盖元件电极的树脂上进行激光加工,形成导通孔以后采用镀层填充导通孔,进行PCB与元件的电气连接。导通孔连接方式的特征是元件的电极上接合直接镀铜(Cu)层。由于没有介入表面安装中使用的焊料或者凸块那样的接合部,所以期待着与多层板的内部线路同等的低连接电阻和高连接可靠性,另外还可以采用全层IVH(Interstitial Via Hole)使用的导电胶进行导通孔连接,与多层板的层间连接同样的导电胶用于与元件的连接,采用同时进行埋置和连接的汇总积层工艺可以简化工程复杂的元件埋嵌基板的制造工艺。
上面介绍了按照埋嵌元件的安装技术分类的埋嵌元件基板的种类和大致的制造工艺。下面参照迄今的开发事例介绍埋嵌元件基板的制造中采用的各种安装技术。
3 焊盘连接方式的埋嵌元件基板
焊盘连接方式中在内层基板上安装元件以后,采用绝缘树脂埋置。嵌入的元件分为裸芯片(Bare Die)和其它元件,下面介绍连接用的表面安装技术。
3.1 裸芯片粘结方式
图3表示了利用倒芯片安装嵌入裸芯片的工艺。

图3(a)表示在裸芯片的电极上形成金(Au)堆积凸块。使用NCP与PCB的电极进行加热加压连接的方式。PCB的电极表面上没有进行镀金(Au)或者镀锡(Sn)等,而是原本的铜(Cu)。铜(Cu)表面上施行粗化处理,旨在提高与树脂的附着力。加热加压连接时,接合部必须维持压缩应力,对于提高连接可靠性至关重要。图3(a)中着眼于NCP的热机械特性,选择高弹性和高膨胀系数的树脂可以获得充分实用的连接可靠性。
另外还有使用ACP代替NCP的热压连接的安装方法。在裸芯片的铝(Al)电极上形成金(Au)球凸块以后,涂布底胶ACP,实施加压加热,即可电气连接。接合可靠性与NCP时同样取决于底胶树脂的物理性能。图3(b)表示了使用银(Ag)胶凸块和ACP的连接方式。PCB的电极上印刷银(Ag)胶形成银(Ag)凸块,涂布底胶ACP使用倒芯片粘结器热压接合。裸芯片的电极上没有形成铜(Cu)或者金(Au)凸块而是采用铝(Al)进行热压连接。
图3(b)的热压连接银(Ag)胶凸块的连接技术在积层板中已经量产化,它是应用了利用导电性凸块的层间连接技术(B2it,Buried Bump InterconnectionTechnology)。
图3(a)和(b)与多层板制造技术相组合的元件嵌入基板的实用化比例,利用NCP和ACP的元件连接技术,采用导电性凸块进行层间连接。制造利用导电性树脂凸块连接的双面板,
埋嵌元件PC 相关文章:
- 埋嵌元件PCB的技术(三)(12-08)
- 埋嵌元件PCB的技术(二)(12-08)
- 电源设计小贴士 1:为您的电源选择正确的工作频率(12-25)
- 用于电压或电流调节的新调节器架构(07-19)
- 超低静态电流电源管理IC延长便携应用工作时间(04-14)
- 电源设计小贴士 2:驾驭噪声电源(01-01)
