HID灯镇流器中UniFET II MOSFET的性能和效率
摘要: 先进的单元结构和寿命控制技术已同时增强了功率MOSFET的导通电阻和反向恢复性能。 本文介绍一种新开发的平面MOSFET—UniFETTM II MOSFET—具有显著提高的体二极管特性,另外还介绍了其性能和效率。 根据寿命控制的集中程度,UniFET II MOSFET可分为普通FET、FRFET和Ultra FRFET MOSFET,其反向恢复时间分别为传统MOSFET的70%、25%和15%左右。为了验证全新MOSFET的性能和效率,用带混频逆变器的150 W HID灯镇流器进行了实验。结果证明,两个UniFET II MOSFET可取代两个传统MOSFE和四个附加FRD,并且无MOSFET故障。
引言
尽管反向恢复特性差,但在许多开关应用中,功率金属氧化物半导体场效应晶体管(MOSFET)的体二极管作为一种续流二极管得到广泛使用。 然而,许多应用最近都报告了功率MOSFET故障 [1-4]。 高电压功率MOSFET一般分为超级结(SJ) MOSFET和平面MOSFET。 超级结MOSFET的导通电阻(RDS(on))相当低,开关性能非常快,这是因为它拥有电荷平衡结构,且输入栅极电荷(Qg)要比平面MOSFET的低得多[5-7]。 这两个参数的乘积(Qg* RDS(on))作为器件的品质因数(FOM)。 此外,超级结MOSFET的体二极管反向恢复性能要比平面MOSFET [6]的高。 但是,超级结MOSFET需要更为复杂且昂贵的外延工艺,而且其体二极管性能的提升存在局限性,因为多外延层结构导致难以进行深入寿命控制。 而另一方面,制造平面MOSFET只需采用一个外延层即可,从而很容易进行深入寿命控制。 因此,可大幅提升平面MOSFET的体二极管反向恢复性能,以防出现MOSFET故障[8]。

据报道,在先前的操作[9-12]中,MOSFET故障是由双极结型晶体管(BJT)和nMOS的误导通以及反向恢复模式下体二极管的dv/dt较高所造成的。 这三种类型的MOSFET故障机理可以通过快速体二极管性能得到改善。 在反向恢复模式下,体二极管性能越快,则复位电流越小。 MOSFET故障中位移电流的效应在[9-10]中已进行了充分研究。 通常情况下,MOSFET的反向恢复特性比快速恢复二极管(FRD)要差[8,15-17]。 功率MOSFET的体二极管具有超长反向恢复时间和高反向恢复电荷。
MOSFET的固有体二极管已在许多应用中被用作关键元件,而且其特性已得到改进。 铂注入[13]和电子辐照[14]等寿命控制可增强MOSFET体二极管的性能。 FRFET® MOSFET[8]和Ultra FRFETTM MOSFET [16]均具有快速反向恢复特性Trr和Irr,分别于2008年和2009年开发。 但是,这两个MOSFET都有一定的缺点,比如:高导通电阻和漏源极泄漏电流。 因此,其应用范围仅限于冷阴极荧光灯(CCFL)背光单元(BLU)逆变器之类的应用,在这类应用中,更快的体二极管性能优先于由其高导通电阻特性造成的传导损耗[8,16]。

最近,在开发UniFETTM II MOSFET(一种高度优化的功率MOSFET)的过程中大大改进了dv/dt强度、体二极管性能和输出电容的存储能量(COSS),同时还将负效应(比如增大的导通电阻)降至最低[17]。 尤其是,UniFET II MOSFET的dv/dt强度和反向恢复性能得到充分提高,而且它们还不会引起器件故障。
本文介绍UniFET II MOSFET强大的体二极管特性,而且还提供能够证明其用于150 W室内HID灯镇流器中混频全桥逆变器的效率的实验结果。

UniFET II MOSFET
功率MOSFET的结构及其故障机理
功率MOSFET因其栅极驱动功能简单、开关速度快及其他特性,成为最常用的功率器件。 通常情况下,功率MOSFET采用纵向结构,称为DMOS(双扩散MOS)。 DMOS功率MOSFET的纵向结构及其等效MOSFET电路如图1所示。 该纵向结构因漏极和源极位于硅晶圆的两对面而适用于高电压器件,通过扩大外延层(漏极漂移区)可提高高电压阻隔能力,同时还可增大沟道导通电阻。
在功率MOSFET中,要注意三种类型的异常故障模式,如下所述[9-10]。
寄生BJT误导通
从根本上说,寄生双极结型晶体管(BJT)的基极和发射极对源极金属来说很普遍。 因此,不应激活寄生BJT。 然而,事实上,基极与源极金属之间存在极小的体电阻(Rb),如图1所示。 如果漏极体电容(Cdb)上出现高强度的dv/dt,则巨大的位移电流便会流经Rb,而且Rb上的电压将会变得足够大(大于-0.65 V),直至触发寄生BJT。 由于负温度系数(NTC),一旦寄生BJT导通,便会形成过热点,而且还会集中更多电流,这最终会导致器件发生故障。
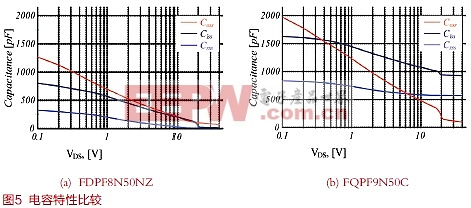
nMOS沟道无意导通
dv/dt过高也会导致nMOS沟道意外导通。 如果MOSFET的漏极与源极之间出现的dv/dt过高,则巨大的位移电流(Cgd × dv/dt)将会流经由栅极至漏极电容(Cgd)、外部栅极电阻(Rg)和并行栅极至源极电容(Cgs)形成的路径,如图1(b)所示。 如果Cgs相对小于Cgd,则更多的电流将流经Rg,因此Rg上的压降将超过MOSFET的阈值电压(VGS(th))。 其结果是,MOSFET将会导通,而自热现象最终会损坏器件。
- 如何设计一个合适的系统电源(上)(11-20)
- 什么是MOSFET(11-26)
- 包含热模型的新型MOSFET PSPICE模型 (11-26)
- 用IGBT代替MOSFET的可行性分析(11-27)
- MOSFET的谐极驱动(11-27)
- 扩展升压稳压器输入、输出电压范围的级联 MOSFET (11-30)
