ops &沉金
我这有一个BGA规格 焊盘直径:0.4mm 间距:0.4mm
实际做layout焊盘:0.3mm
上面打有激光盲孔 直径:0.22mm 内径:0.1mm
最小线宽线距:0.06mm
问一:
这样的BGA是做OSP好还是沉金好?或osp+沉金?(优缺点?)
我现在理解的是:
osp
优点:价格便宜,焊接强度好。
缺点:须在有限时间内使用完。
沉金
优点:可以长时间保存,可焊性强。
缺点:价格贵。
osp+沉金
优点:不知道
缺点:制作过程繁琐,且比单沉金更贵,良率也不高。
问二:
BGA PAD在打盲孔后有必要做填孔的电镀工艺吗?
在这种情况下用哪种好?(osp/沉金/osp+沉金)
你的焊盘间距是外径到外径的吧,不是中心到中心
1.osp+沉金 比全板沉金要便宜
你选择做那种工艺都问题不大,osp一般环境良好的情况下保存期半年,开封了2天内用完
沉金好很多了,保存1-1.5年,但是价格贵一些
2.可以不做电镀填平,在MTK的影响下,0.4pith的SMT工艺很成熟了,何况你的是0.8pith(我这有一个BGA规格 焊盘直径:0.4mm 间距:0.4mm9 )。
我倒是很奇怪你的做法 这些规格对你0.8pith来说都是偏小的
我这有一个BGA规格 焊盘直径:0.4mm 间距:0.4mm
实际做layout焊盘:0.3mm
上面打有激光盲孔 直径:0.22mm
内径:0.1mm
最小线宽线距:0.06mm
BGA规格
搞错了,是0.4pith 孔0.25mm
阅读权限: 20

。
你的BGA是0.4pith的,焊盘直径0.25,焊盘间距0.4
你PCB焊盘直径做0.25就可以了,盲孔0.25/0.1
工艺做全板沉金或者OSP+沉金都可以,看你是成本控制还是可靠性控制了。
最小间距0.1
pad和pad中间不能走线
如果按照这样我就不能走线了,那BGA中间出线咋办?
所以我才做成了上面的那种规格,勉强挤下了0.06mm的线。不知道有没什么更好的办法?
可以局部做0.075/0.075的,表层直接拉,第二层盲孔出去,第三层往BGA内部拉,再埋孔出去,
第一层和第三层分别向外、内走,第二层通过0.075/0.075规则向外拉即可
su
不知道方不方便把你的邮箱给我?想请你帮帮忙,看看我这个板子,给我点建议?如何设计能做好这个板子,我这头次画四层板,而且还是带盲孔埋孔的。真不知道怎么下手。
另外先提两个问题:
1.对于埋孔我有些疑问,埋孔是在内层走线,四层板的话,如果使用埋孔就是2-3层咯?那我的IC又是在top层的,这样怎么做到埋孔?(top层IC打孔到gnd?再转到第三层?这样不就变成盲孔了?)
2.如附件3线MIPI的每对线都在ic的第一和第二排,如果第一排直接走,第二排打孔,每对走线都不在一个层上对它也会有影响哦。如何处理比较好?
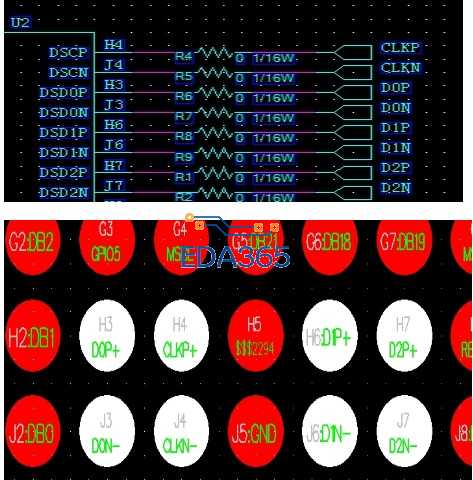
1.我没说清楚,是BGA第三层的线,先打盲孔,再打埋孔出去
2.第一排先TOP走一小段,再打孔,一起走第二层,你走MIPI线前最好先计算好阻抗,走线走哪一层。
没办法一次给10分~~还得两分两分来。晕
真的很谢谢你 su
