英特尔将RFIC和基带IC内置于电磁屏蔽基板制成SiP封装
英特尔开发出了集成有RF IC(RF芯片)和基带IC(BB芯片)的基板内置型SiP(System In a Package),并在"2014 ECTC(国际电子元件与技术会议)"上发表了相关演讲,演讲题目是"Active Die Embedded Small Form Factor RF Packages for Ultrabooks and Smartphones"。英特尔希望通过将上述两种芯片集成在一个封装内使封装面积减小一半,用于"Ultrabook"及智能手机。封装采用了全新结构(图1),利用已有的基板凹腔加工技术以及凹腔内的电镀技术设置屏蔽层,在嵌入的芯片与其他芯片之间阻断噪声。
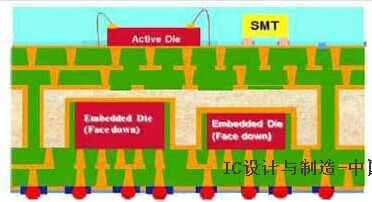
英特尔在2013年的ECTC上发表了使用在封装基板内嵌入电容器的技术开发的服务器用微处理器封装。作为该技术的延伸,此次又开发了在带有屏蔽层的封装基板中嵌入有源元件的技术。由此可以看出,英特尔将基板内置型SiP视为延续性技术开发的一环。
(1)由BB芯片和RF芯片构成的基板内置型SiP的封装尺寸为10mm×10mm,有221个引脚。试制了内置BB芯片后在基板上对RF芯片做引线键合和倒装的封装。
(2)内核基板为2层,厚250μm,在安装芯片的部分形成了凹腔。在内核层的正反面构建了两层30μm厚的绝缘层。在内核层设置了深176.25μm的凹腔并做电镀处理,使之发挥RF屏蔽作用。
(3)与芯片连接的微孔的直径为40μm,基板一侧定位焊盘的直径为70μm。
(4)芯片厚度为150μm。焊盘为外围单列,间距为75μm,尺寸为50μm(图2)。试制了直接嵌入连接的芯片,以及通过再布线转换成175μm间距后设置铜柱(直径100μm、高10μm)的芯片。
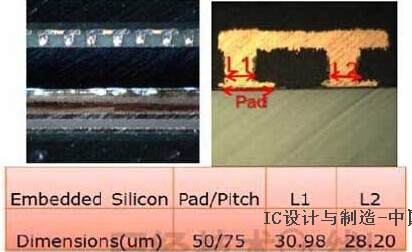
根据反射损失的模拟结果以及RF芯片传输信号强度的实测结果,确认内置有源元件的该基板内置型SiP达到了RF/BB芯片的SiP要求的性能指标。该封装的特点如下:(a)封装面积减半;(b)通过将有源器件内置于基板并与焊盘直接布线,信号传输距离变短;(c)凭借基板内屏蔽层,芯片间的噪声被阻断;(d)RF特性(反射损失、信号完整性及插入损失)达到性能指标的要求;(e)热模拟的结果显示,以倒装方式内置芯片(封装基板侧)时,有结温低的倾向,也就是说,至封装基板的热传导路径短。
- 英特尔发布3G XMM6260、LTE 7060通信芯片(02-15)
- 英特尔推出低价3G手机射频SoC芯片(08-09)
- Cinterion推出基于英特尔?无线通信芯片的M2M模块(01-04)
- 加入4G战争 英特尔出货首款多模、多频段商用4G LTE调制解调器(11-03)
- ANSYS与英特尔合作推出面向Intel Custom Foundry客户的功耗、EM和可靠性验收参考流程(06-15)
- 英特尔展示无线充电桌子:可供多台设备同时充电(06-15)
