Intel高管表示2015年Intel有望将III-V族技术投入实用
时间:01-13
来源:cnBeta.com
点击:
Intel公司技术战略主管Paolo Gargini日前在爱尔兰都柏林举办的欧洲产业策略研讨会(Industry Strategy Symposium Europe)上强调并展示了Intel在III-V族技术方面的最新进展,并称2015年Intel将把这项技术投入实用。
大家都知道,目前用于制造CMOS晶体管沟道部分的主要材料是硅,硅是一种在元素周期表中隶属IV族的元素,而III-V族技术的核心则是采用在元素周期表中隶属III/V族元素的材料来制作管子的沟道部分。身为国际半导体技术发展路线图(International Technology Roadmap for Semiconductors:ITRS)组织主席的Gargini,在这次会议上表示2015年Intel在III-V族技术方面的进展将可为用户提供性能比硅晶体管高两倍,而耗电量则与硅晶体管相当的解决方案。
尽管Intel已经成功推出了32nm级别制程技术,但在这次展示过程中,Gargini强调传统的硅材料CMOS要想进一步缩小关键尺寸,就必须对制造技术进行相当复杂的改进升级,比如采用立体结构晶体管(FinFET)或进一步提升沟道的硅应变程度等。
Gargini表示,尽管FinFET多门晶体管的次临界斜率(sub-threshold slope)相比传统平面型晶体管更为陡峭(所谓的次临界指的是管子的栅源电压Vgs低于门限电压Vth,而所谓的次临界斜率,指的是在次临界状态下漏源电流Ids的对数值与Vgs的比率曲线的斜率,更陡峭的次临界斜率,意味着管子开闭状态切换的速度越快),同时管子的静电特性方面也有所改善。但这种技术也存在管子寄生电阻/电容较大,而且制造工艺相比平面型晶体管更为复杂的缺点。
文件中继续解释道:"而继续增强沟道区载流子迁移率的技术则同样可以得到更高的性能和更低的功耗。III-V族元素化合物材料相比传统的硅材料在载流子迁移率方面具有一定的优势,其中又以铟锑化合物材料的载流子迁移率为最高。镓砷化合物材料的载流子迁移率比纯硅高8倍左右,铟砷化合物材料的载流子迁移率则比纯硅高33倍左右,铟锑化合物材料的载流子迁移率则可达到硅的50倍以上!"
文件中并展示了多种使用III-V族元素化合物制作MOS管的构造方案,其中一种构造是在镓砷化合物基体表面制出由铟锑化合物材料构成的沟道,Intel将这种管子成为量子阱场效应管(quantum-well FET),这种构造方案既可用于制造耗尽型晶体管,又可适用于增强型晶体管。
另外,Gargini还展示了另外一种沟道材料为InGaAs的量子阱场效应管,这种场效应管的栅极部分首次使用了high-k材料绝缘层结构。最后,Gargini还在文件中回顾了2007-2009年Intel公司在国际电子设备会展上(IEDM)会议上的展示材料,这些材料主要是介绍Intel公司在晶体管技术方面的技术进展。
Gargini的结语是:"这种在硅材料基底上制造非硅材料沟道的技术很有希望被用于制造低功耗设备。"
发布者:博子
大家都知道,目前用于制造CMOS晶体管沟道部分的主要材料是硅,硅是一种在元素周期表中隶属IV族的元素,而III-V族技术的核心则是采用在元素周期表中隶属III/V族元素的材料来制作管子的沟道部分。身为国际半导体技术发展路线图(International Technology Roadmap for Semiconductors:ITRS)组织主席的Gargini,在这次会议上表示2015年Intel在III-V族技术方面的进展将可为用户提供性能比硅晶体管高两倍,而耗电量则与硅晶体管相当的解决方案。
尽管Intel已经成功推出了32nm级别制程技术,但在这次展示过程中,Gargini强调传统的硅材料CMOS要想进一步缩小关键尺寸,就必须对制造技术进行相当复杂的改进升级,比如采用立体结构晶体管(FinFET)或进一步提升沟道的硅应变程度等。
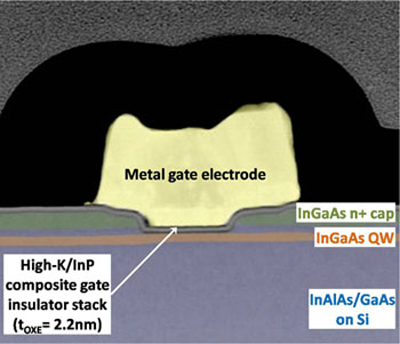 |
Gargini表示,尽管FinFET多门晶体管的次临界斜率(sub-threshold slope)相比传统平面型晶体管更为陡峭(所谓的次临界指的是管子的栅源电压Vgs低于门限电压Vth,而所谓的次临界斜率,指的是在次临界状态下漏源电流Ids的对数值与Vgs的比率曲线的斜率,更陡峭的次临界斜率,意味着管子开闭状态切换的速度越快),同时管子的静电特性方面也有所改善。但这种技术也存在管子寄生电阻/电容较大,而且制造工艺相比平面型晶体管更为复杂的缺点。
文件中继续解释道:"而继续增强沟道区载流子迁移率的技术则同样可以得到更高的性能和更低的功耗。III-V族元素化合物材料相比传统的硅材料在载流子迁移率方面具有一定的优势,其中又以铟锑化合物材料的载流子迁移率为最高。镓砷化合物材料的载流子迁移率比纯硅高8倍左右,铟砷化合物材料的载流子迁移率则比纯硅高33倍左右,铟锑化合物材料的载流子迁移率则可达到硅的50倍以上!"
文件中并展示了多种使用III-V族元素化合物制作MOS管的构造方案,其中一种构造是在镓砷化合物基体表面制出由铟锑化合物材料构成的沟道,Intel将这种管子成为量子阱场效应管(quantum-well FET),这种构造方案既可用于制造耗尽型晶体管,又可适用于增强型晶体管。
另外,Gargini还展示了另外一种沟道材料为InGaAs的量子阱场效应管,这种场效应管的栅极部分首次使用了high-k材料绝缘层结构。最后,Gargini还在文件中回顾了2007-2009年Intel公司在国际电子设备会展上(IEDM)会议上的展示材料,这些材料主要是介绍Intel公司在晶体管技术方面的技术进展。
Gargini的结语是:"这种在硅材料基底上制造非硅材料沟道的技术很有希望被用于制造低功耗设备。"
发布者:博子
- Nehalem现场展示:四核心8线程/3.2GHz(03-04)
- 用于Intel移动互联网设备的首版Skype现在推出(01-09)
- 风河推出商用级Android平台(11-10)
- Intel下周一将推出新款Atom N470上网本处理器 主频提升至1.83GHz(01-27)
- QLogic I/O连接方案搭配Intel最新处理器提升新一代服务器性能(09-10)
- CEE:三种新功能使数据处理中心完美联网 (03-10)
