徘徊十字路口 微影技術面臨發展鴻溝
时间:10-02
整理:3721RD
点击:
微影技術已發展至抉擇的十字路口,而且很可能正朝著錯誤的方向前進。微影技術可說是支配著‘摩爾定律’所闡釋IC製程縮微週期的一項關鍵生產技術。儘管目前這一技術看來依然可行,而且其壽命已經遠遠超出了所有人的預期;然而,它很可能在不久的將來失去發展動力。因此,後續的相關技術研究早在幾十年前就已經展開。
時至今日,在四種主要的下一代微影(NGL)候選技術中,包括超紫外線(EUV)、多波束無光罩(multi-beam maskless)以及奈米壓印(nanoimprint)等三項技術都已經遠落後於其開發時間表了。
特別是EUV技術,至今已消耗了大量的研發時間與資金,卻仍未能取得多少成果,因而促使一些業界人士呼籲必須重新導向並集中各方研發力量。此外,奈米壓印技術本身存在著多層對位的堆疊精密度(overlay)與吞吐量等問題,而多波束技術則仍然在研發階段。
至於第四種下一代微影候選技術──定向自組裝(directed self-assembly),雖然是一種十分具有遠景的研究課題,但卻遲遲未能開始進行研發。
正如Piper Jaffray公司分析師Gus Richard所指出的,業界早已體認到,如果沒有一個可行的下一代微影方案(大多數人均認定將會是EUV),摩爾定律的微縮進程將減緩,同時“半導體產業長久以來穩定的成長率也將開始下滑。”因此,業界先行採用193奈米浸潤式微影技術,以便為其在邁向下一代微影技術的共同行動上爭取一些時間。
但由於EUV與其它下一代解決方案的時間表延遲,因此,業界當前的“首要任務仍是延續193奈米技術”,HCP Consulting Services公司負責人Hans Pfeiffer說。為此,晶片製造商們轉而追逐雙重曝光(double patterning)等其它技術。對於這樣一個業已過於昂貴的業務領域而言,這些相關技術更進一步為其增添了複雜度與成本。
ASM公司和Nikon公司均已研發出浸潤式掃描器,據稱可提供更高的吞吐量,以便能多少彌補一些雙重曝光的高昂成本。但ASML公司卻又略微延後其掃描器出貨日期──這兩家競爭廠商目前正激烈交戰中,互相攻訐對方的新產品並未達到廣告所訴求的性能指標。
就某方面來說,EUV一直是個‘錢坑’。業界最近才尷尬地坦承,目前仍缺乏EUV計量工具,估計這些相關工具大約需要2億美元以上的資金才足以開發出來。ASML公司一款試生產EUV的工具成本也驚人地高達9,000萬美元的天價。另外,EUV所需的高功率光源與無缺陷EUV光罩都還沒能實現,該技術所用的光阻也尚未完備。
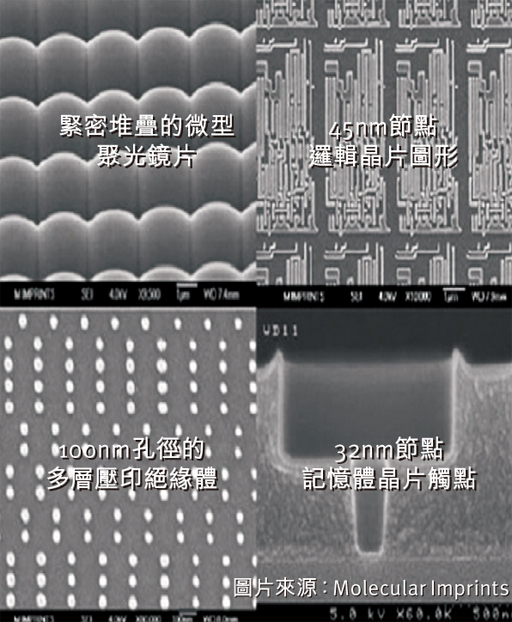
圖1:奈米壓印技術成果:緊密堆疊的微型聚光鏡片(左上)、45nm節點邏輯晶片圖形(右上)、32nm節點記憶體晶片觸點(右下),以及100nm孔徑的多層壓印絕緣體(左下)。
英特爾(Intel)公司在1997年主導EUV LLC聯盟的成立,計劃於2005年以前為該技術在90奈米節點上實現商用化,但業界目前仍在等待商用化的EUV可用工具。三星公司(Samsung)表示相信EUV技術可望在2012年投入使用,然而,大多數業界人士則估計該技術要到2015年才可出現。目前,英特爾公司計劃把浸潤式微影技術擴展到11奈米,並正權衡無光罩與EUV這兩種技術,到底哪一種技術更適於作為微影轉型技術。
有些評論家呼籲,業界應該一起退出對於EUV技術的研發,因為這一開發行動已變得更像是一種利於獲取資助的‘寵兒計畫’(pet project),而非針對產業利益而用於提升微影技術的性能。然而,這一呼聲可能為時已晚。EUV有自己的問題存在,但業界已經做出承諾,同時,傳統的光學微影技術也已經不再具有活力。
“我認為微影技術正朝向錯誤的方向前進,”一位微影技術專家指出。“EUV長期以來一直是吞噬時間與金錢的龐大怪獸。但我確實看不到它成為替代技術的任何可能性。”
“我們把大筆金錢投注於EUV上的原因之一在於,”VLSI Technology公司CEO G. Dan Hutcheson指出,“如果我們不這麼做,摩爾定律將會很快地終結。”
如果說技術障礙的挑戰還不夠,那麼,去年的經濟現實也為微影業務帶來了壓力。根據Barclays Capital公司和Gartner公司等市場觀察家估計,隨著經濟衰退,微影產品市場銷售量下滑了51%。不過,微影市場銷售業務預計將在今年出現高達114%的銷售成長,從2009年的26.4億美元成長到56.7億美元。
這一預測數字應該可以讓持續在晶圓廠中使用193奈米浸潤式掃描器的IC製造商們略感安慰。這項技術原本預期將會在40奈米時遭遇到瓶頸,但IC開發商們現在相信,雙重曝光技術將使掃描器導入低於2x奈米以下製程節點的應用。大多數主導的晶片公司們紛紛起而追逐某種基於該技術的產品類型。不過,由於雙重曝光技術也可能使IC生產成本倍增,因而仍然讓這些廠商們感受某些壓力。
ASML和Nikon公司正競相推出可實現更高吞吐量以彌補雙重曝光技術成本的193奈米浸潤式工具。ASML公司預計最近將會出貨其NXT:1950i微影機器,“但由於在使該工具臻於完善所耗用的時間高於預期,因而導致其交貨時間延期,”Barclays Capital公司分析師C.J. Muse說。而另一個消息來源也表示,“NXT還存在著諸多問題。”
ASML公司的一位發言人聲稱,“該系統並沒有什麼嚴重的問題,而且它很快地就會達到所有的規格要求。”
Some of the negative comments about the NXT:1950i are?clearly coming from the competitorˇs camp,〃 the ASML spokesman said, referring to Nikon. Nikonˇs new machine, the S620D, ?is not running at full spec either,〃 he added.
關於NXT:1950i系統的一些負面評價“很顯然地是來自於競爭對手的陣營”,ASML公司發言人說,此處所指的爭對手當然就是Nikon。Nikon公司新款的微影產品S620D“至今也未能滿足全部的規格要求,”他補充說。

圖2:儘管下一代解決方案懸而未決,但微影市場銷售數字可望在今年出現高達114%的成長率。
一旦這些微影產品符合規格指標並開始供貨,ASML和Nikon公司所提供的新式掃描機能夠讓晶片製造商們擴展其光學微影技術版圖至次30奈米領域。但是,“擴展浸潤式微影到22奈米及其以下卻可能增加成本與複雜度,因而使浸潤式微影在更先進製程節點時較不具有經濟效益,”Piper Jaffray公司的Richard指出。
業界期望下一代微影技術能做好隨時進場的準備。
ASML和Nikon公司也正開發EUV掃描儀。EUV與目前所用的工具存在明顯的差別。它使用13.5奈米波長,其製程步驟必須在真空室中進行。光學元件基本上是透過交錯干涉層以反射光線的無缺陷鏡像。
三星預計將在2012年時導入EUV應用。據稱該公司計劃先自DRAM的生產中導入這項技術,而非從NAND生產開始。DRAM已成為實現IC製程微縮的產業推動力量。
“DRAM更像是一種二維圖形,具有比NAND多三倍的關鍵層,而這正是我們期望業界推動EUV採用之處,”Barclay公司的Muse說。相形之下,NAND僅有一維圖形,因而2x奈米節點NAND製造商們必須採用193奈米浸潤式與隔層(spacer)雙重曝光技術。隔層技術使用一種關鍵的微影步驟、兩種關鍵蝕刻步驟與化學氣相沈積,以沈積隔層薄膜與硬光罩。
由於邏輯元件的設計規則比記憶體元件更為寬鬆,包括英特爾公司等邏輯元件製造商們能夠延遲過渡到EUV技術。“英特爾在NAND和DRAM元件方面都落後半拍”Muse說。
英特爾希望使193奈米浸潤式技術擴展到15奈米,然後為11奈米製程開發混合搭配方案,並整合傳統掃描儀與EUV或無光罩微影技術(取決於哪一種技術可投入使用),英特爾公司資深研究員Yan Borodovsky說。Yan Borodovsky同時也是英特爾公司技術與製造部門的先進微影技術總監。
在晶圓代工方面,台積電(TSMC)公司仍未在EUV、無光罩和採用雙重曝光的193奈米技術之間做出抉擇。
由於微影技術缺乏明確的後續產業鏈,晶片製造商們甚至考慮是否該放棄該技術的方案。創新方法包括使用矽穿孔(TSV)技術,以使有元件在三維結構中進行堆疊;此外,還可尋求另類結構與材料,如FinFET與石墨烯電晶體。
然而,誠如下一代微影技術一這些可能的替代技術現在看來也只不過是紙上談兵。

圖3:國際半導體技術藍圖(ITRS)的微影技術開發計劃表。
作者:馬立得
時至今日,在四種主要的下一代微影(NGL)候選技術中,包括超紫外線(EUV)、多波束無光罩(multi-beam maskless)以及奈米壓印(nanoimprint)等三項技術都已經遠落後於其開發時間表了。
特別是EUV技術,至今已消耗了大量的研發時間與資金,卻仍未能取得多少成果,因而促使一些業界人士呼籲必須重新導向並集中各方研發力量。此外,奈米壓印技術本身存在著多層對位的堆疊精密度(overlay)與吞吐量等問題,而多波束技術則仍然在研發階段。
至於第四種下一代微影候選技術──定向自組裝(directed self-assembly),雖然是一種十分具有遠景的研究課題,但卻遲遲未能開始進行研發。
正如Piper Jaffray公司分析師Gus Richard所指出的,業界早已體認到,如果沒有一個可行的下一代微影方案(大多數人均認定將會是EUV),摩爾定律的微縮進程將減緩,同時“半導體產業長久以來穩定的成長率也將開始下滑。”因此,業界先行採用193奈米浸潤式微影技術,以便為其在邁向下一代微影技術的共同行動上爭取一些時間。
但由於EUV與其它下一代解決方案的時間表延遲,因此,業界當前的“首要任務仍是延續193奈米技術”,HCP Consulting Services公司負責人Hans Pfeiffer說。為此,晶片製造商們轉而追逐雙重曝光(double patterning)等其它技術。對於這樣一個業已過於昂貴的業務領域而言,這些相關技術更進一步為其增添了複雜度與成本。
ASM公司和Nikon公司均已研發出浸潤式掃描器,據稱可提供更高的吞吐量,以便能多少彌補一些雙重曝光的高昂成本。但ASML公司卻又略微延後其掃描器出貨日期──這兩家競爭廠商目前正激烈交戰中,互相攻訐對方的新產品並未達到廣告所訴求的性能指標。
就某方面來說,EUV一直是個‘錢坑’。業界最近才尷尬地坦承,目前仍缺乏EUV計量工具,估計這些相關工具大約需要2億美元以上的資金才足以開發出來。ASML公司一款試生產EUV的工具成本也驚人地高達9,000萬美元的天價。另外,EUV所需的高功率光源與無缺陷EUV光罩都還沒能實現,該技術所用的光阻也尚未完備。
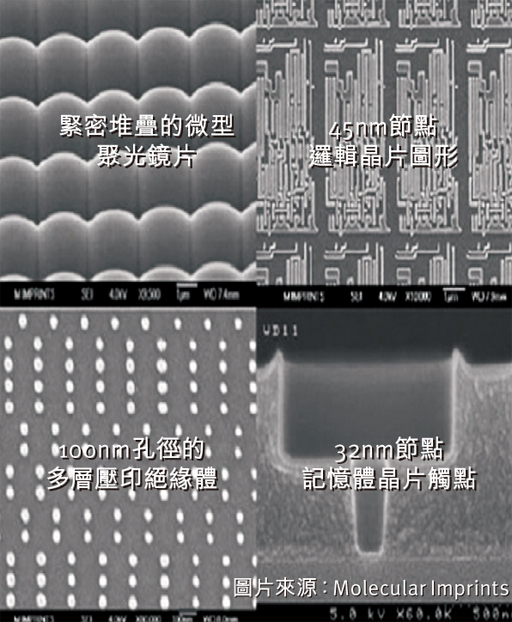
圖1:奈米壓印技術成果:緊密堆疊的微型聚光鏡片(左上)、45nm節點邏輯晶片圖形(右上)、32nm節點記憶體晶片觸點(右下),以及100nm孔徑的多層壓印絕緣體(左下)。
英特爾(Intel)公司在1997年主導EUV LLC聯盟的成立,計劃於2005年以前為該技術在90奈米節點上實現商用化,但業界目前仍在等待商用化的EUV可用工具。三星公司(Samsung)表示相信EUV技術可望在2012年投入使用,然而,大多數業界人士則估計該技術要到2015年才可出現。目前,英特爾公司計劃把浸潤式微影技術擴展到11奈米,並正權衡無光罩與EUV這兩種技術,到底哪一種技術更適於作為微影轉型技術。
有些評論家呼籲,業界應該一起退出對於EUV技術的研發,因為這一開發行動已變得更像是一種利於獲取資助的‘寵兒計畫’(pet project),而非針對產業利益而用於提升微影技術的性能。然而,這一呼聲可能為時已晚。EUV有自己的問題存在,但業界已經做出承諾,同時,傳統的光學微影技術也已經不再具有活力。
“我認為微影技術正朝向錯誤的方向前進,”一位微影技術專家指出。“EUV長期以來一直是吞噬時間與金錢的龐大怪獸。但我確實看不到它成為替代技術的任何可能性。”
“我們把大筆金錢投注於EUV上的原因之一在於,”VLSI Technology公司CEO G. Dan Hutcheson指出,“如果我們不這麼做,摩爾定律將會很快地終結。”
如果說技術障礙的挑戰還不夠,那麼,去年的經濟現實也為微影業務帶來了壓力。根據Barclays Capital公司和Gartner公司等市場觀察家估計,隨著經濟衰退,微影產品市場銷售量下滑了51%。不過,微影市場銷售業務預計將在今年出現高達114%的銷售成長,從2009年的26.4億美元成長到56.7億美元。
這一預測數字應該可以讓持續在晶圓廠中使用193奈米浸潤式掃描器的IC製造商們略感安慰。這項技術原本預期將會在40奈米時遭遇到瓶頸,但IC開發商們現在相信,雙重曝光技術將使掃描器導入低於2x奈米以下製程節點的應用。大多數主導的晶片公司們紛紛起而追逐某種基於該技術的產品類型。不過,由於雙重曝光技術也可能使IC生產成本倍增,因而仍然讓這些廠商們感受某些壓力。
ASML和Nikon公司正競相推出可實現更高吞吐量以彌補雙重曝光技術成本的193奈米浸潤式工具。ASML公司預計最近將會出貨其NXT:1950i微影機器,“但由於在使該工具臻於完善所耗用的時間高於預期,因而導致其交貨時間延期,”Barclays Capital公司分析師C.J. Muse說。而另一個消息來源也表示,“NXT還存在著諸多問題。”
ASML公司的一位發言人聲稱,“該系統並沒有什麼嚴重的問題,而且它很快地就會達到所有的規格要求。”
Some of the negative comments about the NXT:1950i are?clearly coming from the competitorˇs camp,〃 the ASML spokesman said, referring to Nikon. Nikonˇs new machine, the S620D, ?is not running at full spec either,〃 he added.
關於NXT:1950i系統的一些負面評價“很顯然地是來自於競爭對手的陣營”,ASML公司發言人說,此處所指的爭對手當然就是Nikon。Nikon公司新款的微影產品S620D“至今也未能滿足全部的規格要求,”他補充說。

圖2:儘管下一代解決方案懸而未決,但微影市場銷售數字可望在今年出現高達114%的成長率。
一旦這些微影產品符合規格指標並開始供貨,ASML和Nikon公司所提供的新式掃描機能夠讓晶片製造商們擴展其光學微影技術版圖至次30奈米領域。但是,“擴展浸潤式微影到22奈米及其以下卻可能增加成本與複雜度,因而使浸潤式微影在更先進製程節點時較不具有經濟效益,”Piper Jaffray公司的Richard指出。
業界期望下一代微影技術能做好隨時進場的準備。
ASML和Nikon公司也正開發EUV掃描儀。EUV與目前所用的工具存在明顯的差別。它使用13.5奈米波長,其製程步驟必須在真空室中進行。光學元件基本上是透過交錯干涉層以反射光線的無缺陷鏡像。
三星預計將在2012年時導入EUV應用。據稱該公司計劃先自DRAM的生產中導入這項技術,而非從NAND生產開始。DRAM已成為實現IC製程微縮的產業推動力量。
“DRAM更像是一種二維圖形,具有比NAND多三倍的關鍵層,而這正是我們期望業界推動EUV採用之處,”Barclay公司的Muse說。相形之下,NAND僅有一維圖形,因而2x奈米節點NAND製造商們必須採用193奈米浸潤式與隔層(spacer)雙重曝光技術。隔層技術使用一種關鍵的微影步驟、兩種關鍵蝕刻步驟與化學氣相沈積,以沈積隔層薄膜與硬光罩。
由於邏輯元件的設計規則比記憶體元件更為寬鬆,包括英特爾公司等邏輯元件製造商們能夠延遲過渡到EUV技術。“英特爾在NAND和DRAM元件方面都落後半拍”Muse說。
英特爾希望使193奈米浸潤式技術擴展到15奈米,然後為11奈米製程開發混合搭配方案,並整合傳統掃描儀與EUV或無光罩微影技術(取決於哪一種技術可投入使用),英特爾公司資深研究員Yan Borodovsky說。Yan Borodovsky同時也是英特爾公司技術與製造部門的先進微影技術總監。
在晶圓代工方面,台積電(TSMC)公司仍未在EUV、無光罩和採用雙重曝光的193奈米技術之間做出抉擇。
由於微影技術缺乏明確的後續產業鏈,晶片製造商們甚至考慮是否該放棄該技術的方案。創新方法包括使用矽穿孔(TSV)技術,以使有元件在三維結構中進行堆疊;此外,還可尋求另類結構與材料,如FinFET與石墨烯電晶體。
然而,誠如下一代微影技術一這些可能的替代技術現在看來也只不過是紙上談兵。

圖3:國際半導體技術藍圖(ITRS)的微影技術開發計劃表。
作者:馬立得
